译自原文
First demonstration of N-polar GaN/AlGaN/AlN HEMT on Single Crystal AlN Substrates
原文作者
Eungkyun Kim , Zexuan Zhang , Jashan Singhal , Kazuki Nomoto , Austin Hickman , Masato Toita , Debdeep Jena , and Huili Grace Xing, Cornell University, Asahi Kasei Corporation
原文链接
DOI: 10.1109/DRC55272.2022.9855776, IEEE Device Research conference, 2022
后续更优器件性能报道
N-polar GaN/AlGaN/AlN high electron mobility transistors on single-crystal bulk AlN substrates. https://doi.org/10.1063/5.0138939 , Appl. Phys. Lett. 122, 092104 (2023)
项目支持方
美国国家科学基金会(NSF)、Asahi Kasei Corporation(旭化成)
氮化镓的宽带隙和高电子速度使其在商业和国防毫米波应用中极具吸引力。如今,氮化镓高电子迁移率晶体管(GaN HEMTs)能够在毫米波频率下提供高功率,从而抵消这些频率下高大气衰减的影响。然而,基于GaN HEMTs的功率放大器仍然受到散热问题的限制,这突显了HEMT中热管理的重要性。
在这项工作中,我们介绍了在单晶氮化铝(AlN)衬底上具有GaN/AlGaN/AlN异质结构的N极性HEMT器件。AlN缓冲层提供了两个主要优势。它具有约340 W/mK的高热导率,大约比GaN高出50%。其次,由于其约6 eV的大带隙,预计可以减少缓冲层泄漏并提高击穿电压。除了AlN提供的优势外,N极性异质结构相比金属极性(即Al极性)技术还具有几个优点:固有的宽带隙AlGaN或AlN背势垒提供了更强的电子限制,并且可以直接在GaN沟道层形成低电阻欧姆接触。
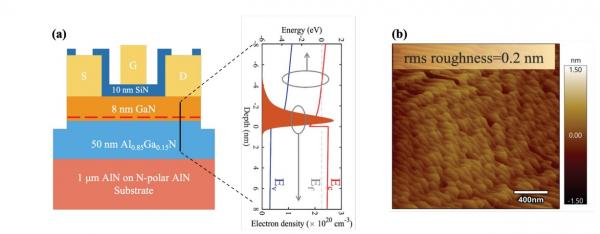
图1(a) 展示了在单晶AlN衬底上N极性GaN/Al0.85Ga0.15N/AlN HEMT器件横截面示意图,右侧显示了能带图,二维电子气(2DEG)的位置以虚线红线表示 (b) 样品生长表面的2×2 um²原子力显微镜图像。
图1(a)展示了HEMT器件横截面和能带图,并显示了GaN/Al0.85Ga0.15N界面上方的二维电子气(2DEG)。通过等离子辅助分子束外延(MBE)生长的外延结构包括一个8 nm厚的GaN沟道、一个50 nm厚的Al0.85Ga0.15N背势垒和一个1 μm厚的AlN缓冲层,生长在单晶AlN衬底上。图1(b)所示的生长表面原子力显微镜图像展示了具有亚纳米均方根粗糙度的光滑表面,且在300K下对生长后的异质结构进行的霍尔效应测量显示出491 cm²/V·s的电子迁移率和4.09 x 10¹³ cm⁻²的2DEG密度,相应的薄层电阻为311 Ω/sq。当冷却至77 K时,几乎没有观察到电子密度的变化,这与2DEG的极化诱导性质一致。制造流程首先通过原子层沉积沉积一层薄薄的Al₂O₃层,以保护反应性N极性GaN表面在加工过程中不受损害。然后通过光刻实现欧姆接触,并通过电子束蒸发沉积Ti/Al/Ni/Au金属堆栈,并在N₂环境中以780 °C退火30秒。然后通过基于氯的ICP干法刻蚀将HEMT隔离,并通过高密度等离子体化学气相沉积制备10 nm硅氮烷栅介质层。最后,通过光刻制备Ni/Au栅极。
在器件制备完成后,使用传输线模型法(TLM)测量了接触电阻Rc = 0.256 Ω·mm,如图2所示。正如预期的那样,制备的器件展示了通过AlN缓冲层的非常低的漏电流,如图3所示。图4显示了制备的HEMT直流特性,栅长为LG = 1.5 µm,栅源距离和栅漏距离为LGS = LGD = 2.25 µm。图4(a, b)所示的转移I-V特性揭示了峰值跨导约为100 mS/mm,开/关比约为12。与许多其他报道的N极性HEMT以及金属极性HEMT相比,这个开/关比相对适中,受到非优化的栅介质层导致的高栅极漏电流的限制。目前正在努力降低栅极漏电流,包括开发栅凹陷结构以降低沟道电荷密度和优化介质层。尽管栅漏极电流较高,但制备的HEMT还展示了有前景的特性,例如如图4(c)所示的超过0.94 A/mm的漏极电流,无需再生长过程的低接触电阻和低缓冲层漏电流。在非故意掺杂的GaN沟道层顶部加入一薄层原位Si掺杂的GaN层后,预计接触电阻将进一步降低。正在对欧姆接触进行详细研究。据作者所知,这是首次在N极性体AlN衬底上制备出N极性GaN/AlGaN/AlN HEMT器件。这些结果将在创建具有最小热问题的高性能射频HEMT中发挥巨大作用。
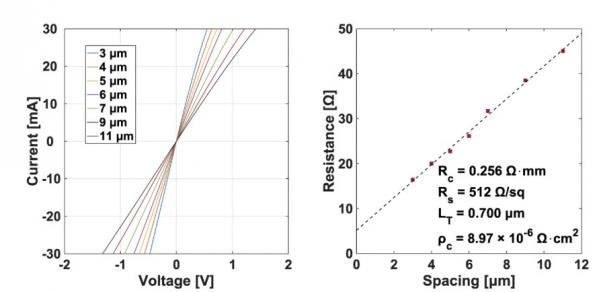
图2 通过TLM(传输线模型法)方法测量源极和漏极与二维电子气(2DEG)的欧姆接触,显示接触电阻 Rc = 0.256 Ω·mm
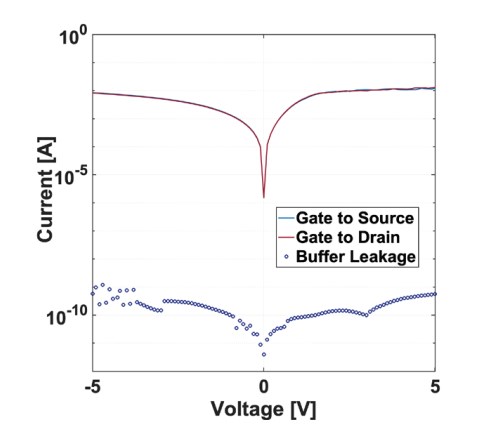
图3 两端测量结果显示通过AlN缓冲层的低缓冲层漏电流
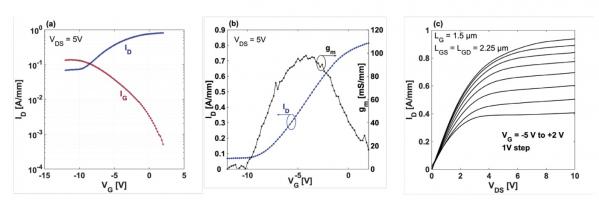
图4 (a) 以半对数刻度显示的转移曲线,红色表示栅漏电流。(b) 以线性刻度显示的转移曲线,显示出约12的开/关比和约100 mS/mm的峰值跨导。(c)曲线族显示了最大漏极电流密度为0.94 A/mm
原文源于【AIP Publishing】
(以上文章由奥趋光电翻译,如有涉及版权等问题,请联系我们以便处理)


























