译自原文
Polarization-induced 2D electron gases in N-polar AlGaN/AlN heterostructures on single-crystal AlN substrates
原文作者
Zexuan Zhang, Jashan Singhal, Shivali Agrawal, Eungkyun Kim, Vladimir Protasenko, Masato Toita, Huili Grace Xing, and Debdeep Jena, Cornell University, Asahi Kasei Corporation
原文链接
https://doi.org/10.1063/5.0145826
Applied Phys. Lett. 122, 212106 (2023)
项目支持方
美国国家科学基金会(NSF)、美国能源部(DOE)科学办公室基础能源科学(BES)、美国空军科学研究办公室(AFOSR)、美国陆军研究办公室(ARO)、旭化成、康奈尔材料研究中心(CCMR)、康奈尔Kavli研究所(KIC)
摘要
极化诱导载流子在实现超宽带隙半导体AlGaN的高电导率方面起着重要作用,这对于从射频和功率电子到深紫外光电器件的各种应用至关重要。尽管具有重要的科学和技术意义,但在N极性AlGaN中关于极化诱导载流子的研究仍然较少。我们通过系统改变8 nm顶层中的Al含量,从x=0到x=0.6,跨越从3.56到4.77 eV的能带隙,报告了在N极性单晶AlN衬底上的N极性AlGaN/AlN异质结中观察到的极化诱导二维电子气(2DEGs)及其性质。随着Al含量的增加,2DEG密度单调递减,从GaN沟道中的3.8 x 1013/cm2降至x=0.6时无法测量的导电性。合金散射限制了x=0.49时2DEG的迁移率低于50 cm2/V·s。这些结果为设计在AlN上的N极性AlGaN沟道高电子迁移率晶体管提供了宝贵的见解,适用于在高电压和高温下的极端电子器件以及紫外器件等。
由于器件性能的许多优点与能带隙的非线性缩放密切相关,超宽带隙(UWBG)半导体,如Ga2O3、AlGaN和金刚石,代表了材料、物理、器件和应用领域的新兴研究方向,范围涵盖了射频(RF)、功率电子与深紫外光电器件以及量子计算和在恶劣环境下的应用。AlGaN通过控制合金中Al的含量,其带隙可以从3.4 eV调节至超过6 eV,因此作为各种电子和光电应用的构建模块,并引起了重大的研究和技术关注。除了它能覆盖广泛的能带隙范围外,AlGaN还是唯一一种可以通过极化工程而非化学掺杂诱导导电沟道(p型和n型)的超宽带隙半导体材料。
与金属极性AlGaN不同,关于N极性AlGaN中极化诱导电子的报道相对有限。类似于在金属极性AlyGa1-yN/AlxGa1-xN异质界面(y > x)观察到的极化诱导二维电子气(2DEGs),正极化电荷和导电势垒在异质界面处也应产生N极性AlGaN/AlN异质结中的2DEGs。尽管这些2DEGs基本上未被研究,但它们可以作为AlN上N极性AlGaN沟道高电子迁移率晶体管(HEMTs)的通道,其中顶部势垒的缺失可能有助于缓解对应金属极性所面临的接触不良问题,同时充分利用宽带隙AlGaN沟道和AlN势垒的大击穿场。
除了沟道的能带隙之外,通过改变AlGaN中的Al组成,还可以预期调节N极性AlGaN/AlN异质结中2DEGs的性质。除了理解N极性AlGaN中载流子传输的重要科学意义,系统研究N极性AlGaN/AlN异质结的组成对器件结构、电学性质和光学性质的影响也具有技术重要性,因为这些性质直接影响到器件性能。此外,由于已知晶格结构缺陷会影响材料的性质并降低器件性能,因此有必要探讨在晶格匹配、结构完整的单晶AlN衬底上(位错密度小于104/cm2)的N极性AlGaN/AlN器件结构与常用的异质衬底(如SiC或蓝宝石)相比的情况,因为AlN与这些异质衬底之间存在较大的晶格失配,导致高位错密度(~109/cm2)。
在这项工作中,我们研究了在单晶AlN上N极性AlxGa1-xN/Al0.85Ga0.15N异质结(x=0至x=0.6)中极化诱导的二维电子气(2DEGs)的形成和性质。顶部AlxGa1-xN和底部Al0.85Ga0.15N层的厚度分别约为8 nm和40 nm。从光致发光(PL)光谱中提取的顶部AlGaN层的光学带隙范围从3.56 eV到4.77 eV。除了电荷控制从x=0时的ns=3.8x1013/cm2减少到x=0.49时的ns=7.6x1012/cm2,最后当x=0.6时无法测量,随着Al含量x的增加,电子迁移率观察到下降,正如预期,在300K时,从大约650(x=0)降到大约40 cm2 /V s(x=0.49),这是由于合金散射造成的。
图1(a)所示的外延异质结是使用带有标准Ga和Al蒸发池以及用于活性N源的射频等离子体源的Veeco GEN10系统中的等离子辅助分子束外延(MBE)生长的。两个Al池用于生长突变异质结。使用KSA仪器公司的反射高能电子衍射(RHEED)装置,配备Staib电子枪,在15 kV和1.5 A下运行,以原位监测生长前沿。使用来自旭化成公司的N极性单晶AlN衬底。在丙酮、异丙醇和去离子水中进行外部清洗(每次10分钟)后,将切割成7x7 mm2的AlN衬底安装在无铟夹具中,装入MBE系统,并在200℃下通宵排气7小时。在外延层生长之前,在MBE生长室中进行了100次原位Al辅助表面清洁循环,以去除N极性AlN衬底表面的本征氧化物和其他化学杂质,并确保通过MBE生长的覆盖层保持N极性,不会反转为金属极性。有关Al辅助清洁过程的详细信息可以在我们之前的工作中找到。
在Al辅助清洗之后,在富Al的优化工艺下生长了500 nm的同质外延AlN层。在将衬底冷却至约900℃以沉积40 nm未掺杂的Al0.85Ga0.15N层之前,过量的Al滴在约1200℃的升高温度下原位脱附。之后,对于GaN沟道样品(x=0),在较低的衬底温度约810℃下沉积了8 nm的GaN层。类似的生长条件已在之前的报告中使用过。相比之下,对于所有AlGaN沟道样品(x>0),8 nm的AlxGa1-xN沟道层在与Al0.85Ga0.15N层相同的生长温度下生长,且在异质结处没有生长中断。通过Al单元温度控制AlxGa1-xN层中的Al组成,所有的AlGaN(和GaN)层都在金属富集的生长条件下生长,并且在生长后,衬底在生长温度下保持足够长的时间,以便在冷却至室温之前原位脱附过量的Ga滴。
在AlN和顶部AlxGa1-xN层之间插入一个Al0.85Ga0.85N“杂质阻挡”层的目的是通过阻止在富Al生长条件下AlN生长前沿上漂浮的不需要的杂质(如硅),以到达期望产生2DEG的顶部异质结,从而提高2DEG迁移率。
图1(b)展示了图1(a)中所示的五个样品的对称2θ/ω X射线衍射(XRD)扫描,这些扫描使用PANalytical Empyrean装置在45 kV和40 mA下测量,采用Cu Kα1辐射(1.5406 Å)。厚度条纹的观察表明存在突变异质界面。随着x的增加,由于与衬底的晶格匹配更好,条纹被更清晰地解析出来。此外,基于图1(a)中的层结构的模拟(未显示)与测量的XRD光谱之间的良好一致性证实了目标结构的实现。围绕GaN、AlGaN和AlN的非对称(105)衍射峰进行了倒易空间映射(RSMs),以量化AlGaN(和GaN)层的应变。本研究中的所有AlGaN和GaN层都被发现完全应变到下面的AlN上。图1(c)和1(d)分别展示了x=0和x=0.6的样品的典型RSM扫描。量化GaN和AlGaN层中的应变对于理解传输特性很重要,因为应变会影响压电极化,从而影响二维电子气(2DEG)密度。

图1. (a) 本研究中外延层结构示意图。 (b) 不同铝含量的对称2θ/ω XRD扫描。 [(c) 和 (d)] 从样品中取得的非对称(105)衍射的RSMs,其中(c) x=0 和 (d) x=0.6。 (e) 10 x10 μm2 和 (f) 2 x 2 μm2 原子力显微镜(AFM)显微照片图,显示了x=0.49时生长表面的平滑表面和平行原子台阶。

图2. 在T = 300K时,N极性AlxGa1-xN/Al0.85Ga0.15N异质结的光致发光谱,顶部AlGaN沟道层的铝组分x不同,显示了来自所有样品的光子发射。
样品的表面形貌使用原子力显微镜(AFM)(Asylum Research Cypher ES)进行检查。图1(e)和1(f)展示了以x = 0.49的生长表面形貌作为一个例子,在一个10x10 μm²区域[图1(e)]中测量得到光滑表面,没有螺旋状隆起,均方根(rms)粗糙度为0.5 nm。图1(f)中放大的2x2 μm²扫描显示平行原子台阶,暗示了阶梯流生长模式。从其他样品中也观察到类似的表面形貌,具有亚纳米级rms粗糙度及平行原子台阶(10x10 μm²扫描)。没有观察到表面粗糙度和铝组分之间有明确的相关性。
图2显示了五个样品在300K下的光致发光(PL)光谱。所有样品都是从顶部用193 nm ArF准分子激光器激发的。所有五个样品都观察到顶部AlGaN沟道层的近带边PL发射。顶部AlGaN层PL峰值分别在348 nm(3.56 eV)、312 nm(3.96 eV)、300 nm(4.14 eV)、274 nm(4.52 eV)和260 nm(4.77 eV),对应于GaN、Al0.2Ga0.8N、Al0.33Ga0.67N、Al0.49Ga0.51N和Al0.6Ga0.4N沟道样品。当沟道的铝组分x增加时,PL峰发生蓝移,这直接表明了沟道带隙的增加。值得注意的是,通过PL测量的AlGaN沟道的表观光学带隙可能与体带隙不同,这是由于能量量子化、量子限制斯塔克效应(QCSE)和应变。有趣的是,从所有样品中也观察到来自较宽带隙Al0.85Ga0.15N背势垒的大约234 nm(5.3 eV)的光子发射。这里没有尝试对PL光谱进行详细分析,计划在未来的工作中进行。
霍尔效应测量是通过将焊角铟接触点连接到N极性AlGaN沟道的二维电子气(2DEGs)来对样品进行的。结果总结在表I中,并与PL得到的能带隙一起给出。除了Al0.6Ga0.4N沟道的样品外,所有样品都显示出可测量的2DEGs,直到低温,这是由于它们的极化诱导起源所预期的。图3(a)显示了使用自洽薛定谔-泊松求解器模拟的能量带图,沟道Al含量x = 0、0.33、0.6,表面势垒高度qφB为0.3 eV(如已报道的N极性GaN)以及单晶AlN内零电场作为边界条件。如图3(b)所示,在顶部AlxGa1-xN/Al0.85Ga0.15N界面处诱导出高密度2DEGs。已发现底部界面的次级沟道没有可测量的导电性。目前仍需研究次级沟道高电阻率背后的原因,一个可能的解释是深能级中的局域化。以下讨论将仅关注顶部异质界面处的2DEGs。
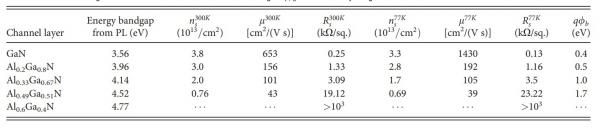
表I. 本研究中研究的N极性AlxGa1-xN/Al0.85Ga0.15N HEMT异质结的结构细节,以及通过PL测量的AlGaN沟道的相应带隙和在300和77K下通过霍尔效应测量的2DEG密度ns、迁移率μ。片电阻Rs > 103 kΩ/sq. “…”表示无法使用霍尔效应测量提取传输的电阻性样品。表面势垒高度qφb是通过将模拟与测量的2DEG密度拟合得出的。

图3. (a) 对于三种不同的Al组成x = 0(绿色)、0.33(棕色)和0.6(蓝色)模拟的能量带图,表面势垒高度qφB约为0.3 eV。 (b) 模拟的电子密度证实了AlxGa1-xN/Al0.85Ga0.15N界面处存在高密度2DEGs。底部界面的次级沟道没有显示出可测量的导电性。
随着沟道中Al含量的增加,顶部异质界面的导带边缘Ec向费米能级移动[图3(a)],而2DEG密度减小[图3(b)]。虽然固定表面势垒高度为0.3 eV的能量带图模拟定性地解释了沟道中铝含量增加时2DEG密度减小的趋势,但它预测在Al0.6Ga0.4N/Al0.85Ga0.15N处有高密度(ns > 1x1013/cm2)的2DEG,这与该样品没有任何可测量导电性的情况形成对比。同时,它还预测x = 0.49时的2DEG密度为ns > 1.7x1013/cm2,这是对测量值0.76x1013/cm2的高估超过两倍。这一点在图4(a)中进一步说明:尽管对于x≤0.2的测量300K 2DEG密度与qφB = 0.3 eV的模拟相当吻合,但对于x≥0.33,测量得到的2DEG密度下降得比预测的要快得多,这表明对于高铝含量AlGaN沟道,固定表面势垒高度qφB = 0.3 eV有很大的偏差。例如,从图4(a)预期x=0.49的表面势垒高度约为2 eV。表I的最后一列列出了与每个样品在300K下测量的值相匹配的AlxGa1-xN/Al0.85Ga0.15N界面模拟的2DEG密度的表面势垒高度qφB。使用X射线光电子能谱(XPS)技术已经报告了金属极性AlGaN的表面势垒高度随铝组分的增加而增加。有趣的是,对于N极性AlGaN也观察到了类似的趋势。

图4. (a) 不同样品中AlGaN沟道层铝组分x的函数,在77K(实心圆圈)和300K(空心圆圈)下测量的2DEG霍尔密度。模拟的2DEG密度(灰色线条)也作为铝组分的函数绘制出来,对于不同的表面势垒高度qφB(插图),并且与实验数据很好地吻合。 (b) AlGaN 2DEG沟道中铝组分x的函数,在77K(实心圆圈)和300K(空心圆圈)下的电子迁移率。灰色曲线显示了对于相同的合金散射势UAL= 2 eV的不同载流子密度ns计算的合金散射迁移率,这证实了高铝组分AlGaN沟道2DEGs中的主要散射机制是合金散射。 (c) 各种铝组分的PL能带隙与片状电导率的关系。高导电性对于高电流是所需的,而大能带隙则更倾向于高击穿电压。
图4(b)显示了作为Al组成x函数的77 K(实心符号)和300 K(空心符号)霍尔效应迁移率的测量值。随着Al组成x的增加,2DEG迁移率单调降低,从x=0时的μ > 1400 cm²/V·s降至x=0.49时的μ < 50 cm²/V·s(77 K时)。显然,77K时的迁移率相比其300K的值增长了超过2倍,这是由于声子散射冻结的预期效果,特别是在GaN沟道(x=0)中。与室温值相比,Al0.2Ga0.8N沟道的低温迁移率也有轻微提高,而Al0.33Ga0.67N和Al0.49Ga0.51N沟道2DEGs的变化几乎可以忽略不计。2DEG迁移率随Al含量增加而降低以及高Al含量AlGaN沟道中温度依赖性几乎可以忽略的现象,都可以通过合金无序散射来解释,这是一种温度无关的过程。众所周知,合金散射限制的迁移率作为合金组成x的函数呈U形曲线,这是由于1/{x(1-x)}的依赖性。因此,在本工作研究的合金组成范围内,Al含量x的增加应导致2DEG迁移率降低。图4(b)中的线条绘制了给定2DEG密度范围(从1 x 1013到4 x 1013/cm²)的Al含量函数的合金散射限制2DEG迁移率。合金散射势UAL= 2 eV的拟合结果与实验数据吻合良好,并且落在金属极性AlGaN报告的UAL典型范围(介于1.3和2.2 eV之间)内。高Al含量AlGaN沟道中近乎温度独立的2DEG迁移率对于需要在高且可变温度下稳定运行的应用来说很有吸引力。
如前所述,此处观察到的N极性AlGaN/AlN二维电子气(2DEGs)可以实现AlN上N极性AlGaN沟道HEMT器件。这些器件预计将带来比对应的Al极性单晶基AlN器件中GaN沟道更具吸引力的优势,后者最近已经展示出有希望的直流和射频特性,例如开态电流为2.6 A/mm,最大振荡频率(fmax)为100 GHz。此外,由于缺少顶部势垒,利用N极性结构中的AlGaN沟道有潜力克服金属极性AlGaN晶体管一直面临的主要挑战之一——接触不良的问题。对于射频HEMT,沟道的片状电导率σ和能带隙Eg是预测其性能的关键指标。这是因为高σ有助于实现大电流和低接入电阻,而大Eg也有助于2DEG沟道中的高临界电场。
为了更好地说明这些2DEGs在射频和功率应用中的潜力,本研究中五个样品的实验测量室温霍尔片状电导率σ作为PL实验测量能带隙Eg的函数,在图4(c)中绘制。随着沟道Eg的增加,σ迅速下降。这在σ和Eg之间呈现了一个权衡,用于AlGaN沟道HEMT的使用。另一方面,Al0.6Ga0.4N/Al0.85Ga0.15N异质结中缺乏原生长2DEG对于需要常闭操作的应用可能是有利的,例如电力开关和能量转换,尽管需要采用巧妙的策略,如选择性区域硅离子注入,以降低此类设备的接入电阻。因此,本研究为异质结设计以及针对下一代射频和功率电子学的N极性AlGaN沟道HEMT的设备工程提供了有用的实验数据。
总之,本研究报告了对使用MBE在单晶AlN上生长的N极性AlxGa1-xN/Al0.85Ga0.15N异质结的结构、光学和电子输运特性的系统研究,AlGaN沟道组成从x=0变化到x=0.6。光致发光光谱显示AlxGa1-xN沟道的带隙随x的增加而增加,从3.56 eV变化到4.77 eV。观察到极化诱导的2DEGs,2DEG密度从GaN沟道中的约3.8x1013/cm2变化到8 nm厚的Al0.6Ga0.4N沟道中没有可测量的2DEG。发现温度独立的合金散射是高Al含量(x>0.3)AlGaN沟道2DEGs的主要散射机制。这些结果为设计AlN单晶衬底上N极性AlGaN沟道HEMT奠定了基础,以实现高频、高功率和高温性能。
原文源于【AIP Publishing】
(以上文章由奥趋光电翻译,如有涉及版权等问题,请联系我们以便处理)


























