译自原文
Self-sustaining step-flow growth: Preset nano-terraces as diffusion rails for Si-doped AlN by low-temperature MOCVD
原文作者
Huangshu Zhang, Jiacheng Zhong, Jiahao Chen, Jiamin Chen, Zeren Wang, Zhijian Yang, Xuelin Yang, Lun Dai, Jiejun Wu, and Tongjun Yu, Research Center for Wide-Gap Semiconductors, School of Physics, Peking University,State Key Laboratory of Artificial Microstructure and Mesoscopic Physics, Collaborative Innovation Center of Quantum Matter, Peking University Yangtze Delta Institute of Optoelectronics.
原文链接
https://doi.org/10.1063/5.0271592 Appl. Phys. Lett. 126, 172104 (2025)
项目支持方
国家自然科学基金、东莞赛微半导体技术有限公司
摘要
低温掺杂为调控氮化铝(AlN)导电性提供了一种极具潜力的解决方案。作为下一代光电子和电子器件的理想候选材料,AlN的高质量生长通常需要高温工艺,而金属有机化学气相沉积(MOCVD)是目前主流的生长方法。本研究巧妙利用铝吸附原子(Al adatoms)扩散能力受限的特性,通过精确调控其表面行为,成功实现了"自维持台阶流生长"机制,从而显著降低了AlN的生长温度。实验结果表明,在1050℃的生长条件下,该方法能稳定维持台阶流生长模式,制备出厚度达3 μm、电导率高达56.1 kΩ-1 cm-1的高质量Si掺杂AlN薄膜。更令人振奋的是,当生长温度进一步降低至980 ℃(迄今报道的最低生长温度)时,材料的电导率高达115 kΩ-1 cm-1的。这一重要突破不仅深化了我们对掺杂条件下AlN表面动力学的认知,更为其规模化半导体应用奠定了坚实基础。
氮化铝(AlN)作为带隙高达6.2 eV的超大禁带宽度半导体(UWBG),凭借其直接带隙特性,已成为下一代光电子与高功率电子器件的核心候选材料。该材料不仅具有优异的热导率,支持双极掺杂特性,且已实现单晶衬底的制备,展现出推动工业规模化应用的巨大潜力。然而,如何突破掺杂效率低下的瓶颈,仍是充分发挥AlN性能优势的关键科学问题。尽管硅(Si)被广泛认为是AlN最理想的n型掺杂元素,但金属有机化学气相沉积(MOCVD)法制备的Si掺杂氮化铝(AlN:Si)薄膜却存在显著的高电阻率问题。这一现象主要归因于双重机制:其一,铝空位-硅复合体(VAl–nSi)形成的自补偿效应;其二,硅DX跃迁引发的电子局域化效应。值得注意的是,Si掺杂还会显著降低III族空位的形成能,这不仅会进一步加剧自补偿效应,还会在外延生长过程中诱发严重的拉应力。
从抑制铝空位形成和硅DX态重构的角度而言,分子束外延(MBE)技术通过在约800℃的低温条件下实现掺杂,已证实可有效提升材料导电性;与之相比,1000℃左右的离子注入后退火工艺同样能达成类似的掺杂效果。然而,传统金属有机化学气相沉积(MOCVD)工艺必须维持超过1200℃的高温环境才能促进铝吸附原子的充分扩散,且所有通过MOCVD方法制备的Si掺杂氮化铝(AlN:Si)薄膜,其导电率始终未能突破50 kΩ-1 cm-1这一阈值——这一困扰学界二十余年的性能瓶颈至今仍未得到有效解决。由此可见,若能妥善解决低温生长过程中引发的一系列技术难题,开发新型低温生长工艺将成为提升MOCVD法制备Si掺杂AlN导电性能的有效突破口。具体而言,在低温生长条件下,铝原子扩散动力学受限会诱发三维岛状生长模式,并伴随严重的表面粗糙化现象。值得注意的是,Si掺杂剂在此过程中会表现出独特的反表面活性剂效应,不仅无法改善表面形貌,反而会进一步加剧其恶化程度;与此同时,由此产生的结构缺陷也会导致材料导电性能出现显著衰减。基于上述分析,探索具备可扩展性的低温生长新方法,实现MOCVD技术制备高质量Si掺杂AlN薄膜的产业化应用,已成为当前亟待解决的关键科学问题。
在本研究中,我们创新性地利用铝吸附原子(Al adatoms)的本征可控性,成功攻克了低温生长这一关键技术难题。通过发展基于过饱和驱动的台阶工程策略,研究团队精确预设台阶结构,实现了铝吸附原子在台阶边缘的高效并入,进而构建出可在宽温域内稳定运行的自维持台阶流生长体系。基于简化表面动力学模型,我们在1050℃生长条件下成功制备出具有优异性能的Si掺杂氮化铝(AlN:Si)薄膜:在精心设计的外延衬底上,薄膜厚度达到3 μm,电导率高达56.1 kΩ-1 cm-1。尤为重要的是,该方法在980℃这一迄今最低生长温度下仍展现出卓越的工艺适应性,实现了115 kΩ-1 cm-1的突破性导电性能。本研究成果不仅为MOCVD技术开辟了低温生长高质量Si掺杂AlN的新路径,更为实现高导电率AlN材料的工业化制备提供了创新解决方案。
本研究采用AIXTRON 3×2英寸近耦合喷淋头MOCVD反应腔体(配备LayTec EpiCurveR TT原位监测系统)进行样品制备,可同步获取生长过程中的温度、反射率及曲率等关键参数。样品表面形貌表征通过Bruker Dimension Icon原子力显微镜(AFM)和Keyence VHX-970F光学显微镜完成。晶体结构分析方面,使用配备CuKα1辐射源的Bruker D8高分辨率X射线衍射仪(HRXRD),分别测量对称与非对称衍射几何条件下的X射线摇摆曲线(XRCs),并获取(105)晶面非对称反射的倒易空间图谱。对于Si掺杂AlN薄膜的残余应力及其深度分布分析,则采用WITec alpha 300R显微共聚焦拉曼光谱系统(激发波长532 nm)进行系统表征。
需要着重指出的是,铝吸附原子(Al adatoms)所表现出的优异可控性,恰恰源于其受限的扩散能力——这一在传统氮化物外延生长理论中被普遍视为根本缺陷的特性,在本研究体系中却转化为独特的优势。具体而言,这种由扩散受限衍生出的可控性主要通过双重机制实现:其一,其外延生长行为具有显著的简约性,能够通过简洁且具有普适性的表面动力学模型进行精确描述;其二,其外延行为对外延表面结构表现出极高的敏感性,从而可通过表面结构设计实现精准调控。如图1(a)所示,铝吸附原子会被有效地限制在台阶结构内部,这些台阶结构犹如"扩散导轨",能够引导吸附原子有序地向邻近台阶边缘迁移并入,进而稳定地延续预设的台阶流生长形貌。这种自维持台阶流生长模式与具有强扩散能力吸附原子的生长行为存在本质区别:后者往往会忽略预先设计的表面结构,随机地在低能位点发生再形核现象。这一对比分析清晰地表明,表面台阶结构的精确设计是实现AlN自维持台阶流生长的核心要素。
为确定适合低温AlN MOCVD生长的台阶宽度参数,本研究基于Burton-Cabrera-Frank(BCF)模型简化体系建立理论分析框架。该模型针对各向同性表面吸附原子在一维扩散条件下的动力学行为进行描述,其边界条件设定为对称状态且未考虑Ehrlich-Schwoebel势垒效应。通过整合经典成核理论,我们系统考察了台阶宽度变化对AlN生长模式转变(从台阶流向二维成核)的临界影响机制(完整推导过程见补充材料)。如图1(b)所示,研究获得突破性发现:当台阶宽度缩减至特定阈值时,系统可在更低温度条件下维持稳定的台阶流生长模式。定量分析进一步表明,在保证可接受生长速率的前提下,若需实现1100℃以下的低温台阶流生长,台阶宽度须严格控制在50 nm以下。
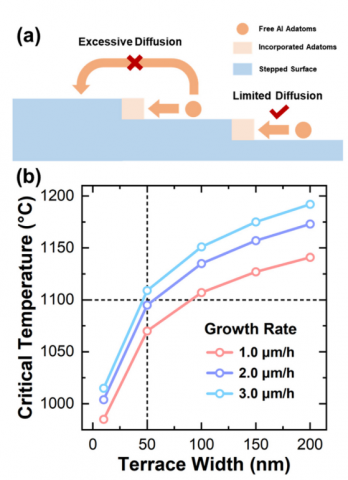
图1(a)外延生长过程中吸附原子在台阶表面迁移行为的简化动力学模型示意图。(b)通过耦合简化BCF模型与经典成核理论,系统揭示了台阶宽度对维持台阶流生长模式临界温度的影响规律,即在不同台阶宽度条件下,临界温度随设定生长速率的变化关系。
台阶宽度能够通过调节过饱和度以及衬底斜切角来实现精准调控。在本研究中,我们选用过饱和度调控法,这种方法具有高度的灵活性,能够方便地根据实际需求对台阶宽度进行调节。实验初期,我们采用物理气相沉积与面对面高温退火相结合的工艺,在蓝宝石衬底上制备出高质量的AlN籽晶层。该工艺不仅能够成功获得优质的籽晶层,还能有效消除蓝宝石衬底原生台阶所产生的影响。具体操作过程如下:将溅射态的AlN薄膜置于氮气氛围中,在1700℃的高温条件下进行长达5小时的退火处理。经过这样的处理后,外延表面能够清晰地呈现出Al极性。在此基础上,我们通过金属有机化学气相沉积(MOCVD)的方法生长500 nm厚的非故意掺杂AlN恢复层。在这个过程中,我们重点通过调节V/III比来优化铝吸附原子的扩散行为,从而有效抑制三维岛状生长和台阶团聚现象。为了实现生长参数的动态平衡,我们采用了交替V/III比的策略。图S2详细展示了在不同V/III比条件下,样品表面形貌的演变过程。图2(b)和图2(c)分别展示了两种具有典型台阶宽度的表面形貌,这两种台阶宽度对应的平均宽度分别为46.8 nm(窄台阶模板NTT)和193 nm(宽台阶模板WTT),具体可参见图2(d)。这两种模板均呈现出单原子层台阶结构,并且其均方根粗糙度(RMS)均低于0.1 nm。表S2中列出了模板生长的主要工艺参数。通过XRD与拉曼光谱的综合分析(图S3),我们证实HTA - AlN、NTT和WTT样品在结晶质量和应变状态方面具有相似性。

图2(a)展示了窄台阶模板(NTT)和宽台阶模板(WTT)的制备原理示意图,其核心调控手段是通过周期性改变V/III比来实现表面形貌的精确控制。(b)和(c)分别为NTT与WTT的原子力显微镜(AFM)表征图像,清晰显示两种模板均形成了具有单原子层台阶特征的平整表面。(d)为沿(b)和(c)图中虚线进行线扫描分析的结果,定量数据表明NTT和WTT的平均台阶宽度分别为46.8 nm和193 nm。
随后,我们运用同一炉次的MOCVD工艺,在NTT和WTT模板上分别制备了厚度为3μm且无裂纹的Si掺杂氮化铝(AlN:Si)薄膜,旨在开展对比研究。由图1(b)可知,生长温度设定为1050℃,远低于常规工艺所需的1200℃。反应腔室压力稳定维持在50 mbar,以氢气作为载气,其总流量为3.12×10⁵ μmol/min。前驱体流量设置如下:三甲基铝(TMAl)的流量为29.6 μmol/min,氨气(NH₃)为3569 μmol/min,硅烷(SiH₄)为4.30×10⁻³ μmol/min。在此低温条件下,实现了1.01 μm/h的较高生长速率。后续研究结果显示,该生长参数组合适用于NTT模板,却不适用于WTT模板,此结果与图1(b)的理论预测高度相符。
图3(a)对比呈现了NTT与WTT模板上3 μm厚Si掺杂氮化铝(AlN:Si)薄膜在633 nm波长监测下的原位光学反射率动态曲线。数据显示,在整个外延生长过程中,反射率曲线的峰谷特征始终保持稳定,这一现象有力证实了薄膜表面始终遵循二维生长模式,从而维持了原子级光滑的表面形貌。然而,光学显微镜观测结果(图3(b)与图3(c))却清晰揭示了两种模板上薄膜表面的显著差异:NTT模板生长的AlN:Si薄膜表面仅存在零星分散的微小凹坑;与之形成鲜明对比的是,WTT模板生长的薄膜表面则同时存在高密度分布的凹坑群和大量规则排列的六角形小丘结构。
为探究表面形貌演化机制,本研究额外制备了厚度为0.5 μm的Si掺杂氮化铝(AlN:Si)对比样品,并采用原子力显微镜(AFM)对样品光滑区域进行表征分析,结果如图3(e)与图3(f)所示。图3(e)显示,NTT模板在整个外延生长过程中始终维持稳定的台阶流生长模式,仅观察到台阶边缘存在轻微曲折现象。与之形成鲜明对比的是,图3(f)揭示WTT模板表面呈现显著的不稳定性特征——在台阶表面过早出现岛状形核现象(虚线标示区域)。随着外延层厚度增加,这些岛状结构逐渐发生融合或与台阶边缘合并,导致台阶宽度增加且曲折程度加剧。值得注意的是,这种台阶展宽现象会进一步促进新岛状结构的形核,致使岛间平均间距持续扩大。当台阶宽度超出铝吸附原子扩散调控范围时,系统将丧失维持稳定台阶流生长模式的能力,具体表现为既无法有效抑制岛状结构融合,又导致大量六角形凹坑的形成[参见图S4(a)和S4(b)]。

图3(a)对比呈现了NTT与WTT模板上3 μm厚Si掺杂氮化铝(AlN:Si)薄膜在633 nm监测波长下的原位光学反射率曲线。图3(b)和图3(c)分别展示了NTT与WTT模板上3 μm厚AlN:Si薄膜的光学显微镜表征图像。图3(d)和图3(e)则系统呈现了NTT与WTT模板上AlN:Si薄膜在0.5至3 μm厚度范围内的表面形貌原子力显微镜(AFM)动态演化过程。
此外,在含螺旋位错分量的穿透位错周围会形成螺旋状岛状结构[图3(f)中实线标示区域]。这些结构在生长过程中不断扩展并相互融合,最终形成六角形小丘——该现象在图3(c)的光学显微镜图像中得到了清晰验证。系统分析表明,WTT模板表面的形貌特征呈现显著恶化趋势,具体体现在四个方面:台阶宽度分布不均、台阶边缘呈现明显曲折、表面存在高密度凹坑分布,以及出现异常增殖的六角形小丘结构。

图4(a)、(b)分别展示了NTT与WTT衬底上3.0 μm厚Si掺杂氮化铝(AlN:Si)薄膜的对称(002)晶面X射线摇摆曲线和不对称(102)晶面X射线摇摆曲线;图4(c)、(d)则对应呈现了两种衬底样品的非对称(105)晶面X射线倒易空间映射图谱。图4(e)呈现了NTT与WTT衬底上3.0 μm厚AlN:Si薄膜在生长过程中的原位曲率动态变化曲线。图4(f)、(g)分别展示了NTT与WTT衬底上AlN薄膜的拉曼光谱深度剖析结果,其中黑色虚线标明了无应变单晶AlN的特征E2(高)声子频率位置。
图4(a)与图4(b)分别呈现了3 μm厚Si掺杂氮化铝(AlN:Si)薄膜在(002)和(102)晶面的X射线摇摆曲线测试结果。数据显示:在NTT衬底上生长的样品,其(002)晶面半高宽(FWHM)为79.6角秒,(102)晶面为167角秒;相比之下,WTT衬底上生长的样品,相应晶面半高宽分别增大至135角秒和213角秒。这一对比结果表明,尽管制备温度相对较低,但所获得的AlN:Si薄膜仍保持了卓越的晶体完整性。
这种生长技术能够有效调控Si掺杂氮化铝(AlN:Si)薄膜的应变状态。如图4(c)所示,NTT衬底上生长的样品其AlN(105)晶面X射线衍射谱在压缩应变弛豫方向仅呈现轻微展宽;相比之下,图4(d)中WTT衬底样品则出现了新的衍射峰,表明其应变状态已转变为压缩性减弱且更稳定的状态。通过原位曲率曲线[图4(e)]对应力演变进行深入分析,证实外延生长过程中会产生拉应变。基于Stoney方程对这些曲线进行斜率分析发现:NTT衬底样品产生的拉应变较少,而WTT衬底样品则表现出显著的拉应变积累,并通过图4(d)中新增衍射峰的出现证实其已弛豫至稳定应变状态。图4(f)和图4(g)展示的AlN EH 2声子频率深度剖析拉曼光谱表明,与NTT衬底样品相比,WTT衬底样品的AlN EH 2峰位向接近无应变状态发生偏移。这些实验结果揭示,WTT衬底样品中额外的拉应变主要源于成核岛合并过程——该现象在保持高度压缩应变状态的NTT衬底样品中并未观察到。因此,NTT衬底上自维持台阶流生长模式可有效抑制拉应变产生,这为制备高质量AlN:Si厚膜提供了新的技术途径。
为探究电学特性,采用磁控溅射工艺在样品表面制备了Ti/Al/Ni/Au(30/180/50/100 nm)金属复合电极层,并依据圆形传输线模型(CTLM)设计电极图案,电极间距设定为3~40μm。随后在950℃条件下进行60秒快速热退火处理。通过Keithley 4200 SCS半导体参数分析仪测量电流-电压(I-V)特性曲线以评估材料电导率。图5(a)和图5(b)分别对比展示了NTT与WTT衬底上样品的I-V测试结果,图5(c)则系统呈现了电阻值随电极间距的变化规律。基于图5(c)数据的拟合分析:

其中r为外半径,d为电极间距,LT为转移长度,特定接触电阻率ρc计算公式为 ,获得NTT与WTT衬底上样品的方块电阻分别为59.4 kΩ/□和263 kΩ/□,特定接触电阻率分别为1.1×10⁻³ Ω·cm²和6.7×10⁻² Ω·cm²。
,获得NTT与WTT衬底上样品的方块电阻分别为59.4 kΩ/□和263 kΩ/□,特定接触电阻率分别为1.1×10⁻³ Ω·cm²和6.7×10⁻² Ω·cm²。
基于公式σ = 1/(Rsh·t)(式中σ表示电导率,t为Si掺杂氮化铝薄膜厚度),经计算得出:NTT衬底上样品的电导率达56.1 kΩ-1cm-1,而WTT衬底上样品的电导率为12.6 kΩ-1cm-1。由于NTT衬底上的样品保持了自维持台阶流生长模式,其结构缺陷(包括位错、晶界及凹坑等)显著减少,有效抑制了载流子陷阱、补偿效应及散射过程,从而显著提升了电导率。同时,NTT衬底样品表面呈现光滑洁净的特征,这不仅有利于欧姆接触的形成,还可有效降低特定接触电阻率。上述结果表明:通过精确调控表面台阶结构所实现的低温自维持台阶流生长模式,是制备高导电性Si掺杂氮化铝薄膜的有效方法。
我们进一步证实,在NTT衬底上实现自维持台阶流生长的温度可突破至980℃这一迄今最低纪录,该温度值显著低于图1(b)理论预测值(约1050℃)。如图S5所示,NTT衬底样品在980℃生长条件下仍保持优异结晶质量,其电导率高达115 kΩ-1cm-1。相比之下,WTT衬底上相同温度(980℃)生长的AlN:Si薄膜则呈现显著的三维岛状生长模式,表面粗糙度急剧增大,并表现出超高电阻的整流行为——由于CTLM测试方法在此条件下失效,其电学性能无法与NTT衬底样品形成有效对比。

图5(a)、(b)分别呈现了NTT与WTT衬底上样品在圆形传输线模型(CTLM)测试中,不同电极间距条件下的电流-电压(I-V)特性曲线;图5(c)则系统展示了NTT与WTT衬底样品的电阻值随电极间距变化的规律,其中虚线为基于实验数据的拟合曲线,用于精确提取方块电阻与特定接触电阻率两个关键电学参数。
必须着重指出,尽管生长工艺仍存在优化空间,但本研究方法已证实可有效提升材料电导率。从本质上讲,氮化铝(AlN)的电学输运机制呈现出高度复杂性,其核心影响因素包括:高密度表面态、强极化效应,以及小电子亲和能、低电子浓度与费米能级钉扎效应等多重物理机制的协同作用,这些因素共同导致欧姆接触形成过程异常复杂。基于上述科学问题,常规循环传输线模型(CTLM)测试仅能实现"有效电导率"的相对比较。若要深入揭示电学测试数据背后的物理本质,亟需开展系统性的基础研究。我们正在推进的后续研究工作将重点聚焦于这些关键科学问题的解析。
综上所述,本研究创新性地利用铝吸附原子有限的扩散特性,成功构建了一种具备自维持特性的有序台阶流生长技术。通过精确调控台阶宽度以形成扩散通道,该技术在低温条件下仍能实现稳定的台阶流生长模式。实验结果证实:在1050℃生长温度下,该技术有效解决了低温生长与Si掺杂共同引发的表面失稳难题,成功制备出厚度达3 μm的无裂纹、高质量的Si掺杂氮化铝薄膜,其电导率高达56.1 kΩ-1cm-1;当生长温度进一步降低至980℃时,薄膜仍能保持115 kΩ-1cm-1的优异电导率。此项突破性技术不仅显著拓展了氮化铝外延生长的工艺窗口,为深入理解其外延生长机制提供了全新理论视角,同时可有效降低热预算与设备需求,从而大幅降低生产成本。本研究为氮化铝材料在半导体领域的产业化应用开辟了新途径。
原文源于【AIP Publishing】
(以上文章由奥趋光电翻译,如有涉及版权等问题,请联系我们以便处理)


























