译自原文
Low Resistance Non-Alloyed Ohmic Contacts to High Al Composition n-type AlGaN
原文链接
https://arxiv.org/abs/2512.08871v1, submitted on 9 Dec 2025
原文作者
Joseph E. Dill*,1 Xianzhi Wei,2 Changkai Yu,2 Akhansha Arvind,3 Shivali Agrawal,4 Debaditya Bhattacharya,3 Keisuke Shinohara,5 Debdeep Jena,3, 2, 6 and Huili Grace Xing*3.2.6
1) School of Applied & Engineering Physics, Cornell University
2) Department of Materials Science and Engineering, Cornell University
3) School of Electrical and Computer Engineering, Cornell University
4) Department of Chemical and Biomolecular Engineering, Cornell University
5) Teledyne Scientific and Imaging, Thousand Oaks
6) Kavli Institute at Cornell for Nanoscale Science, Cornell University
项目支持方
美国国防部高级极化研究局(DARPA)、美国能源部(DOE)科学办公室基础能源科学(BES)、由DARPA资助的半导体研究公司(SRC)、美国国家科学基金会
摘要
氮化物电子和光电器件中,与高铝组分(>70%)n型 AlxGa1−xN超宽带隙半导体层形成欧姆接触,通常需要通过剥离工艺和高温(>700°C)热合金化来制备。这些条件常导致制备结构的显著形变,并对器件的所有其他部分施加严苛的热负荷。在此,我们报道了在铝组分为71%的n+型AlGaN(禁带宽度Eg∼5.4 eV)上制备的非合金、沉积态欧姆接触的方法。该方法制备的载流子浓度约7×10¹⁹ cm⁻³,电阻率为4-5.5 mΩ·cm(此为目前Al₀.₇₁Ga₀.₂₉N材料中报道的最低值之一)。该接触具有线性的I-V特性,在零偏压下的接触电阻率为 ρc=(4.4±1.0)×10−4 Ω⋅cm2。如此高质量的接触通过两种独立的制备方案形成:(i)金属优先图形化,和(ii)金属沉积前采用氧气等离子体去胶进行剥离工艺。考虑到外延所用的AlN单晶衬底中较低的螺旋位错密度、接触外延表面的平滑形貌以及接触的非合金特性,该接触电阻率完全归因于载流子穿过金属-半导体结的热电子场发射。通过低电流注入条件下的接触电阻率提取,我们得以运用热离子场发射模型对这些结果进行建模分析,从而得到 Ti/Al₀.₇₁Ga₀.₂₉N 的势垒高度为 (0.81±0.02) eV。
引言
AlGaN 因其高击穿场强特性在电子应用领域备受关注,同时由于其大直接带隙特点在紫外光电子应用领域也具有重要价值,而这两类应用均需要低电阻的金属-半导体接触结构。对于Al组分不超过75%的Si掺杂n+型AlxGa1-xN材料,其欧姆接触的实现已有大量文献报道,在该组分范围内可通过浅能级掺杂获得载流子浓度>1019 cm-3的自由电子浓度。目前在更高Al组分材料中获得的电导率仍不理想(且缺乏导电性AlN衬底),这主要归因于两个方面:更高的掺杂剂激活能以及受主型本征点缺陷对载流子的补偿作用。
虽然一些AlGaN基场效应晶体管器件结构允许通过巧妙的组分渐变来形成低铝组分的接触表面,但这种便利对于PN结、LED和激光二极管器件并不可行,这些器件需要大面积外延堆叠而活性区无应变诱导弛豫。因此,这些器件结构通常采用准垂直配置,具有一个埋藏的 AlxGa1−xN层,其铝组分x<75%,以实现n型欧姆接触的形成。
许多近期关于在铝组分x>70%的n+型 AlxGa1−xN上形成欧姆接触的报道,利用了钒(V)或钛(Ti)金属堆叠,通过剥离工艺图形化,并在超过750°C的温度下进行退火。虽然已有报道接触电阻率接近 1×10−6 Ω⋅cm2,但这些高温退火通常会导致金属特征的显著形变,同时也对器件异质结构的所有其他组成部分施加了严苛的热负荷。
Smith等人先前对宽禁带半导体 β-Ga2O3欧姆接触的研究报道,通过采用金属优先制备方案而非传统的剥离方法,实现了与相似掺杂密度下合金接触相当的非合金欧姆接触。一项后续的透射电子显微镜(TEM)研究检测到,在金属优先方式制备的金属-半导体界面处存在偶然碳污染,而在传统剥离工艺图形化的界面处存在约1 nm的碳层。通过氧气等离子体去胶处理成功去除表面碳,使得无需合金化即可实现优异的欧姆接触。
先前对n-AlGaN欧姆接触的研究也注意到了UV/臭氧去胶对于形成低阻接触的有效性。本报告采用类似策略,我们展示了在铝组分x=71%的n+型 AlxGa1−xN上形成欧姆接触的方法。该接触具有线性的I-V特性和~4×10⁻⁴ Ω·cm²的接触电阻率,这是通过金属优先图形化方案和适当的去胶去除半导体表面光刻胶残留的剥离图形化方案实现的,两者都旨在减轻金属-半导体界面处的碳污染。

图 1. (a) 在2英寸Al极性AlN单晶衬底上通过分子束外延生长的n+型AlGaN样品的结构示意图(其螺旋位错密度 < 10⁴ cm⁻²)。(b) 通过变温范德堡霍尔测量得到的迁移率(上图)和载流子浓度(下图)。(c) 围绕不对称 ![]() 衍射点的倒易空间映射图。(d) 晶圆尺度的无接触薄层电阻分布图。数据采集自晶圆中心0.7英寸半径范围内;图中边缘区域因未进行测量而有意留白。(e) AlGaN表面的5×5 µm² 原子力显微镜扫描图,其均方根粗糙度为0.60 nm。(f) 围绕 (002) 衍射的ω-2θ X射线衍射扫描的测量结果(蓝色)与模拟结果(红色)对比。
衍射点的倒易空间映射图。(d) 晶圆尺度的无接触薄层电阻分布图。数据采集自晶圆中心0.7英寸半径范围内;图中边缘区域因未进行测量而有意留白。(e) AlGaN表面的5×5 µm² 原子力显微镜扫描图,其均方根粗糙度为0.60 nm。(f) 围绕 (002) 衍射的ω-2θ X射线衍射扫描的测量结果(蓝色)与模拟结果(红色)对比。

表1. 本研究中表征的五个n+型Al₀.₇₁GaN样品的霍尔效应表征、制备规格及非合金欧姆接触性能,这些样品的电阻率为4 - 5.5 mΩ·cm(在带隙~5.4 eV的AlGaN材料中,属于报道的最低电阻率之一)。
样品制备
图1(a)显示了本研究所用样品的外延结构。AlGaN:Si样品通过等离子体辅助分子束外延(MBE)在2英寸Al极性AlN单晶衬底上生长,所用设备为Veeco Gen10系统,配备用于Ga、Al和Si的标准泻流池,以及用于提供活性氮的射频等离子体源。衬底在装入MBE系统前,先经过溶剂超声清洗,然后进行酸处理。在外延生长之前,进行原位Al辅助表面清洁,以进一步去除衬底表面的氧化物并避免位错形核。外延生长始于在富Al条件下、热电偶温度为970°C时沉积230 nm厚的AlN层。随后原位解吸过量的Al,之后在780°C温度、富Ga条件下生长AlGaN:Si层。Si池温度为1340°C,目标Si掺杂密度为9×10¹⁹ cm⁻³。关于AlGaN:Si的MBE生长的更多细节可在我们之前的报告中找到。
外延生长后,进行X射线衍射(XRD)测量以确定AlGaN层的Al摩尔分数和应变状态。如图1(c)所示,![]() 衍射谱的X射线倒易空间映射(RSM)证实AlGaN外延层与下层AlN衬底共格应变。AlGaN层的Al摩尔分数通过对称XRD ω-2θ扫描沿(002)衍射确定[见图1(f)]为71%。图1(e)显示了通过原子力显微镜(AFM)测量的样品表面形貌,在5×5 μm²区域内表现出0.60 nm的均方根(RMS)粗糙度。清晰的原子台阶表明其为台阶流生长模式,而指状特征则归因于显著的Ehrlich-Schwobel势垒诱导的动力学驱动不稳定性
衍射谱的X射线倒易空间映射(RSM)证实AlGaN外延层与下层AlN衬底共格应变。AlGaN层的Al摩尔分数通过对称XRD ω-2θ扫描沿(002)衍射确定[见图1(f)]为71%。图1(e)显示了通过原子力显微镜(AFM)测量的样品表面形貌,在5×5 μm²区域内表现出0.60 nm的均方根(RMS)粗糙度。清晰的原子台阶表明其为台阶流生长模式,而指状特征则归因于显著的Ehrlich-Schwobel势垒诱导的动力学驱动不稳定性
为了评估AlGaN层的电导率,进行了两英寸晶圆的无接触薄层电阻映射[见图1(d)]。我们在整个晶圆上测得平均薄层电阻为93 Ω/□,标准偏差为 6Ω/□。观察到从晶圆中心约100 Ω/□到其边缘附近约80 Ω/□的梯度,这可能是由于MBE生长过程中整个晶圆上的通量和温度不均匀性所致。
将两英寸晶圆切割成8×8 mm²的小片用于欧姆接触制备。本研究选择了五个样品(标记为A-E)[见图1(d)]。从8 K到300 K的温度依赖霍尔效应测量结果如图1(b)所示。测得的载流子浓度(7.2×10¹⁹ cm⁻³)在不同温度下保持恒定,表明Si掺杂已超过莫特相变阈值进入简并态,这种特性非常有利于形成欧姆接触。电子迁移率也随温度保持恒定在17 cm²/Vs。这些输运特性与我们之前在蓝宝石衬底上的AlN模板上通过MBE生长的简并掺杂n+型AlGaN的报道一致,但迁移率高出约2倍,载流子浓度高出约5倍。
五个样品在制备前的室温霍尔效应测量(如表1)显示自由电子浓度范围为6.4-8.2×10¹⁹ cm⁻³,迁移率范围为15-19 cm²/Vs。这些n-Al0.71GaN样品的电阻率为4-5.5 mΩ·cm,是该铝组分AlGaN中报道的最低值之一。还需注意的是,在AlGaN/AlN界面处,极化不连续性可能引入高达1.5×10¹³ cm⁻²的移动空穴。然而,这将被这些简并掺杂的AlGaN:Si层中约2×10¹⁵ cm⁻²的电子面电荷有效掩盖,因此在电阻率分析中可以安全忽略。
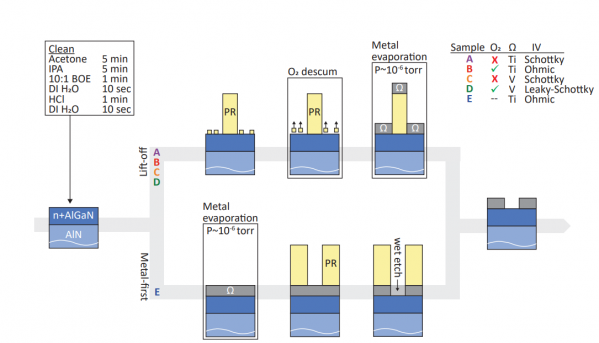
图 2. 通过剥离法(上图;对应样品A-D)与金属优先法(下图;对应样品E)形成欧姆接触的器件示意图与制备工艺流程。右上角注明了每个样品所使用的接触金属(Ω)以及是否进行了氧气等离子体去胶处理。
在切割后的样品上制备了圆形传输长度法(C-TLM)测试结构,其接触金属、半导体表面预处理及金属图形化工艺均进行了系统性调整。具体制备流程如图2所示,并于表1中汇总。样品首先依次在丙酮与异丙醇中各超声清洗5分钟,接着依次浸入10:1的BOE溶液和HCl溶液中各1分钟处理,每次处理间隔均用去离子水漂洗10秒,最后用氮气吹干20秒。
样品A-D采用剥离程序制备,其中n+型AlGaN表面涂覆负性光刻胶,然后通过光刻技术图形化,在光刻胶中开出孔洞以沉积金属堆叠。样品B和D在金属化前进行了2分钟的氧气等离子体去胶,而样品A和C则没有。接触金属堆叠,由Ω/Al/Ti(20nm/120nm/80nm)组成,通过电子束蒸发在约2×10⁻⁶ Torr的压力下沉积,其中 Ω为接触金属(样品A、B为Ti;样品C、D为V)。
样品E采用金属优先方案图形化。在溶剂和酸清洗后,在裸露的n+型AlGaN表面沉积Ti/Au (20 nm/200 nm)金属堆叠。在金属顶部图形化光刻胶以暴露接触之间的沟道区域,然后在115°C下硬烘烤5分钟以形成抗蚀刻的硬掩模。通过浸入Au蚀刻剂TFA中去除Au层,并通过浸入20:1稀释的BOE溶液中去除Ti层。
C-TLM测量与分析
在室温下对C-TLM测试结构进行电学表征,以评估不同表面处理和金属化方案下非合金金属/n+型AlGaN界面处欧姆接触的质量。这些测量结果总结于图3和表1中。C-TLM结构的内半径为 ri=120μm,外半径 ro=ri+d,其中间隙距离d的范围为2至 35μm[见图3(e)]。所有光刻尺寸均通过700倍放大率下的光学显微镜测量确认。直流I-V测量采用四探针配置,向内部圆形焊盘提供电流I,并测量跨越半导体间隙的电压V(见图3(a)插图)。
 图 3. (a) 来自样品A-E、间隙距离约为5 µm的圆形传输线法测试结构的电流-电压特性曲线。(左上角插图)样品A-E的表面处理和接触金属总结。(右下角插图)电流源模式的I-V测量电路配置。(b) 样品E、B和D在2-35 µm间隙距离下的线性I-V特性区域。(c) 基于(b)中线性I-V特性绘制的样品E、B和D的TLM曲线图。(d) 从样品E、B和D上所有测试结构在0至5 mA电流范围内提取的接触电阻Rc的箱形图。对样品A和C测得的非线性I-V曲线无法进行电流密度依赖的Rc分析,因为该分析仅适用于线性TLM测试结构(而不适用于C-TLM,因为一对C-TLM接触不共享相同的电流密度)。每个样品所有测试结构对应的平均比接触电阻率值列于表1中(单位为Ω·cm²)。(e) (左)在四探针配置下测量的已制备C-TLM焊盘的显微镜图像;(右)标示C-TLM测试结构内半径和外半径尺寸的示意图。
图 3. (a) 来自样品A-E、间隙距离约为5 µm的圆形传输线法测试结构的电流-电压特性曲线。(左上角插图)样品A-E的表面处理和接触金属总结。(右下角插图)电流源模式的I-V测量电路配置。(b) 样品E、B和D在2-35 µm间隙距离下的线性I-V特性区域。(c) 基于(b)中线性I-V特性绘制的样品E、B和D的TLM曲线图。(d) 从样品E、B和D上所有测试结构在0至5 mA电流范围内提取的接触电阻Rc的箱形图。对样品A和C测得的非线性I-V曲线无法进行电流密度依赖的Rc分析,因为该分析仅适用于线性TLM测试结构(而不适用于C-TLM,因为一对C-TLM接触不共享相同的电流密度)。每个样品所有测试结构对应的平均比接触电阻率值列于表1中(单位为Ω·cm²)。(e) (左)在四探针配置下测量的已制备C-TLM焊盘的显微镜图像;(右)标示C-TLM测试结构内半径和外半径尺寸的示意图。
剩余原文请点击链接查看https://mp.weixin.qq.com/s/RsUOgWpa8hkVXSlcjT-0zA


























