译自原文
Demonstration of near-ideal Schottky contacts to Si-doped AlN
原文作者
C.E.Quinones, D.Khachariya, P.Bagheri, P.Reddy, S.Mita, R.Kirste, S.Rathkanthiwar, J.Tweedie, S.Pavlidis, E.Kohn, R.Collazo, and Z.Sitar, North Carolina State University
原文链接
https://doi.org/10.1063/5.0174524
项目资助方
美国陆军办公室(US Army Research Office),美国空军科学研究办公室(US Air Force Office of Scientific Research),美国高级研究计划署-能源(US Advanced Research Projects Agency – Energy),美国国家自然基金(US National Science Foundation),美国宇航局空间技术办公室(NASA Space Technology Office)
摘要
实现了室温下理想因子低至1.5的n型Si掺杂AlN肖特基接触,从与温度相关的I–V曲线测试中提取出1.9 eV的与温度无关的肖特基势垒高度。在串联电阻中观察到300meV的激活能,其对应于深硅施主态的电离能。欧姆和肖特基接触在高达650 °C时都是稳定的,且其高温整流性能提升了四个数量级,验证了AlN作为极端环境下电力电子器件平台的潜力。
氮化铝(AlN)由于其超高带隙、高导热率(375W/mK)和高临界场(16MV/cm)而成为kV级电力电子器件领域极具前景的材料。这些优异特性使得其Baliga品质因子比功率器件领域使用的其他材料(如GaN和SiC)大30倍以上。此外,AlN具有非常高的热稳定性和化学稳定性,这使其成为极端环境下应用的理想材料。然而,AlN器件的发展一直受到限制,特别是在AlN上制备的肖特基二极管性能表现不佳,典型器件的理想因子大于5,且漏电流大、导通电阻高。此外,AlN肖特基接触的势垒高度预计大于2eV,且与所使用的金属无关,尽管现有文献报道的肖特基二极管中并没有观察到这个值(报道的范围集中在0.9到1.1eV)。此外,所有报道的肖特基势垒高度都与温度有关,表明存在接触不均匀性。
文献所观察到的器件性能不佳可归因于(1)使用了异质衬底、(2)缺乏可控掺杂。异质衬底如蓝宝石或碳化硅引入了大量的位错和缺陷,表现为平行漏电路径和补偿,从而降低器件的性能。此外,由于缺乏可控的掺杂,使得高质量的肖特基接触和欧姆接触难以形成。近年来,在应对这些挑战方面取得了重大进展。具体来说,随着AlN单晶衬底的商业化,高质量的同质外延AlN薄膜得以实现,平均位错密度可低至103cm-2。此外,点缺陷抑制方法的发展,以及在AlN中可控n型掺杂的成功突破,直接解决了掺杂问题,为AlN基功率器件的制备及其实用化铺平了道路。基于这些进展,我们创记录的实现了几乎具有理想品质因子(理想因子为1.5)的同质外延Si掺杂AlN肖特基接触,该接触的肖特基势垒高度为1.9 eV,且与温度无关,其反向漏电流低,在高真空条件下的高温稳定性高达650℃。
采用垂直型低压(20Torr)感应(RF)加热式的金属有机化学气相沉积(MOCVD)反应炉,在c取向的AlN单晶衬底上生长AlN薄膜。AlN衬底由HexaTech提供,其平均位错密度为103cm-2。在外延生长之前,衬底首先在有机溶剂(丙酮,IPA)中清洗,然后进行酸洗(HCl,HF)。最后,将衬底装入反应炉,在1100℃ NH3下进行退火。有关AlN单晶衬底预处理的更多细节见其它献。以三甲基铝(TMA)、硅烷(SiH4)和氨(NH3)分别作为铝、硅和氮的前驱体。在温度为1300℃,压力为20Torr,NH3流速为3slm,V/III比为6000 (TMA流量为22μmol/min)的条件下,在AlN单晶衬底上生长了1μm厚的非故意掺杂(UID)绝缘AlN层。接下来在相同的压力、温度和前驱体流量下生长500nm厚的Si掺杂AlN。对于Si掺杂层,SiH4流量为7nmol/min,目标Si浓度为1×1018 cm-3。经x射线衍射测定,生长的AlN层位错密度为103量级,原子力显微镜测定的RMS粗糙度<1nm,样品器件如图1所示。通过交流霍尔测量,发现其室温载流子浓度为1.5×1015/cm3,迁移率为160cm2/Vs,电阻率为26Ω*cm。这里应该注意到,Si处于深施主态;对于1018/cm3的[Si],其载流子浓度约为1015/cm3。用Cr/Ti/Al/Ti/Au (20/20/100/45/55nm)金属形成欧姆接触,在氮气环境下950℃退火30秒。肖特基接触由圆形Ni/Au(70/70nm)金属组成,直径从70到600μm,而欧姆接触是一个大面积的矩形(约几mm2)。所有接触都通过荫罩式掩膜形成而非光刻,从而形成横向肖特基-欧姆接触,间距从数百μm到几mm不等。电流-电压(I-V)测量是在直径70μm的二极管上进行,而阻抗测量是在直径600μm的二极管上进行,所有的高温测量都是在高真空条件下进行。
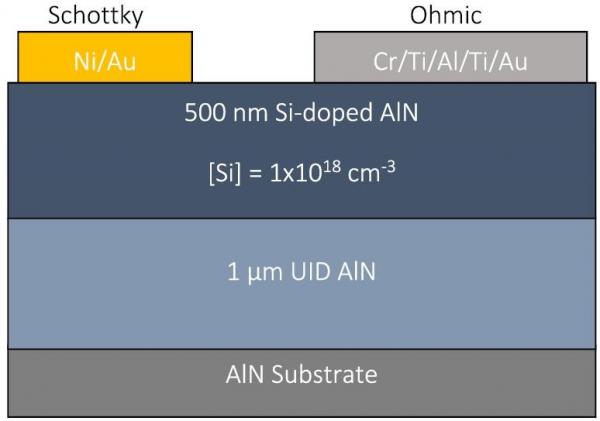
图1:所制备的AlN器件结构横截面示意图
多个肖特基接触到AlN的室温I-V特性如图2所示。在反向偏置下,在-200V下观察到的电流强度小于1nA。在正向偏置中,2V附近观察到一个指数电流区。如图2(a)所示,该区域的理想因子在1.5-1.7之间。这证明电流主要源于热离子发射,正如理想的肖特基二极管。然而,对于远小于势垒高度的偏置,由于电子没有足够的能量来克服肖特基势垒,源于热离子发射的电子电流非常低。正因为热离子发射电流低,通过寄生通路(即位错和缺陷)的漏电流主导了该区域的I-V。随着偏置的增大和势垒高度的降低,热离子发射电流增大,最终超过漏电流。对所有制备的二极管,这均发生在正向偏置电压大约2V时。另一方面,当正向偏置电压大于20V时,I-V呈现出线性关系,这表明电流受到串联电阻的影响,如图2(c)所示。
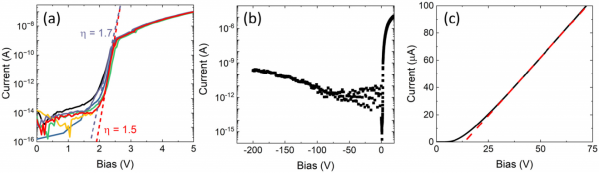
图2:(a) 六个低理想因子肖特基接触在室温、正向偏置条件下的I-V曲线(b)室温反向偏置I-V曲线。(c)室温、正向偏置电压下的I-V线性曲线。
虽然AlN的带隙为6.1eV,但只有在20V正向偏置后,掺Si层串联电阻产生的电流抑制才会显现出来。这一结论被该器件的阻抗图谱证实。该接触的奈氏图(Nyquist plot)如图3(a)所示,频率范围为5khz至10MHz。显然,通常用于肖特基接触建模的单个并联RC等效电路不足以解释所观察到的频率响应。事实上,可观察到三个不同的并联RC元件对总阻抗的贡献,如图3(a)中的实线所示。
图3(b)中的实线显示了偏置范围从-5到+5V时,阻抗实部和虚部的拟合曲线。该分析揭示了依靠偏置的低频RC元件。压敏电容在图3(c)中标绘为1/C2。我们观察到了其中的线性关系,斜率代表有效掺杂浓度为ND-NA=2×1017 cm-3。根据预期的ND,NA应在8×1017 cm-3左右,与此前报道的8×1017 cm-3的结果吻合。显然,依靠偏置的电容与接触处的空间电荷层相对应。剩下的两个RC原件是与偏置无关的(图3(a)中的红色半圆),代表了器件结构中额外的未知势垒,可能是在欧姆接触处,并且是由天然氧化物层造成的。这些额外的势垒用于屏蔽串联电阻直到20V。

图3:(a)偏置电压从-5到+5 V的室温奈氏图。实线表示三个并联RC元件对总阻抗的单独贡献。红色半圆表示从阻抗分析中发现的与偏置无关的RC单元。(b) 奈氏图曲线拟合结果,符号是实测数据,实线为三层RC等效电路模型的拟合线。(c)使用原文所提模型得出的偏置依赖电容的1/C2 与偏置电压对应关系图,曲线拟合得到ND-NA=2×1017 cm-3
图4(a)显示了正向偏置I-V随温度的变化情况。通过在指数区拟合热离子发射模型的I-V特性,得到理想因子和饱和电流的温度函数。从Richardson图的斜率中得出1.9 eV的I-V势垒高度,如图4(b)所示。1.9eV的值与Reddy等人之前报道的2eV的值几乎吻合。此外,理想因子与温度的关系如图4(c)所示,从室温下的1.5下降到440 K时的1.3。电流偏置依赖的增加、低理想因子和得出的势垒高度都是热离子在肖特基势垒上发射的证据,表明I-V由金属-半导体结主导。
有趣的是,在串联电阻区,电流也随着温度的升高而增加。为了说明这一点,在图4(d)中绘制了20V正向偏置下的电流与1/kT间的相互关系。斜率显示了300meV的激活能,这与温度相关的霍尔测量得到的Si供体的激活能结果一致。这有力地证明了在串联电阻区(正向偏置>20V),电流受到掺硅层电阻率的抑制。而在其他报道中,从AlN肖特基接触的I-V特性中也观察到了类似的激活能。

图4:(a) Si掺杂AlN肖特基接触的温度相关正偏置I-V特性。(b) Richardson图显示得出的饱和电流和1/kT的相对关系,以及得出的肖特基势垒高度为1.9 eV。(c)理想因子与温度的函数关系。(d) 20V正向偏置电流与1/kT的相对关系。斜率得出的激活能约为300meV。
由于AlN的耐热性质,肖特基接触将可在非常高的温度下保持稳定。图5为样品在加热前室温、650℃、700℃和加热后室温下的器件I-V特性。随着温度的升高,Si施主电离的比例呈指数增长,从而电流因此增加了几个数量级。可见接触在650℃时是稳定的,在该温度下具有接近4个数量级的整流。然而在700℃时,正向电流减小,表明接触退化。冷却至室温后,导通电压发生变化,如图5所示。但仍有高达7个多数量级的整流效果,导通后正向偏置I-V曲线重合。这些观察结果表明,在700℃之后,电压位移和性能下降可能是由Ni/Au金属堆的合金化造成的,而非因为Si掺杂AlN层的化学降解。

图5:显示肖特基二极管在700℃前、700℃时和700℃后工作情况的I–V曲线
综上所述,AlN的肖特基接触理想因子仅为1.5,使用温度相关的I-V测得了接近2 eV的非温度相关的肖特基势垒高度。这些结果有力地证明了低偏置电压下的电流是由于热离子在肖特基势垒上发射形成。在高偏置电压下,电流主要受到掺Si层电阻率的抑制。通过阻抗谱法对空间电荷层电容进行隔离,从而证实了两个附加势垒的存在。此外,我们还观察到肖特基接触在高达650℃时仍保持稳定,并在冷却到室温时仍能保持整流特性。因此,AlN的肖特基接触可实现接近理想的二极管特性,而这一特性只能通过使用低位错密度的AlN单晶衬底与可控掺杂的AlN外延层相结合来实现。图6展示了AlN上肖特基二极管室温势垒高度与理想因子的函数关系,从而阐明了上述结果的重要性。尽管仍然存在诸多挑战,但本文证实了AlN材料基功率器件在极端环境下运行的巨大潜力。

图6:文献中发表的AlN肖特基二极管的理想因子与势垒高度的关系。空心和实心符号分别表示温度相关和非相关的肖特基势垒高度。
(以上文章由奥趋光电翻译,如有涉及版权等问题,请联系我们以便处理)


























