接上文。。。
自首次报导以来,GaN/AlN p沟道场效应晶体管(pFET)随着器件加工的迭代而不断改进。2012年首次展示了GaN/AlN pFET,当器件被推至-40V漏极偏压时,导通电流超过-100mA mm-1,导通/关断比被限制在3倍。2019年,pFET在合理偏压范围内显示出高电流性能,在-10V漏极偏压下,漏极电流超过-100mA mm-1。最近,GaN/AlN平台上的pFET器件显示出0.42A mm-1 的创纪录高导通电流,如图 9(a)所示。在两个数量级的开/关调制下,观察到66mS mm-1的峰值跨导(图9(b))。这种肖特基门控器件的开/关比受到栅极漏电的限制。通过调整栅极位置、表面处理和加入高K电介质,可以显著降低漏电,同时保持器件的整体性能。高2DHG密度与欧姆接触金属下面的p-InGaN盖层相结合(图 8(a)和(c)),在电流超过100mA mm-1 时实现了1Ω·mm的极低 p型接触电阻。图8显示了该器件的横截面以及氮化物pFET所达到的导通电流基准。0.42A mm-1的导通电流比最接近的氮化物pFET平台高出一个数量级。除导通电流外,GaN/AlN pFET还创下了p沟道GaN器件的小信号增益记录,截止频率(ft)和最大振荡频率(fmax)分别为19.7和23.3GHz,如图9(c)所示。此前对沟道GaN器件的小信号增益记录分别为0.2和0.64GHz。
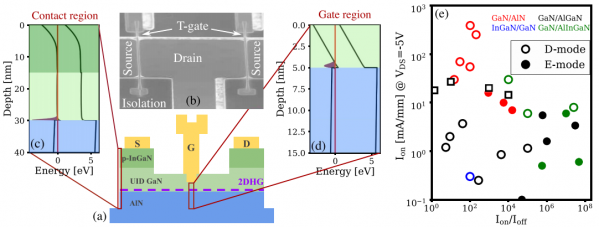
图8:加工完成的GaN/AlN pFET的(a)截面图和(b)SEM 图像,能带图突出显示了(c)接触区和(d)栅极区。请注意沟道区是完全未掺杂的。(e)已报道的III族氮化物pFET的基准图,GaN/AlN异质结构实现了最高导通电流。图表根据Bader等人的研究进行了修改和更新。
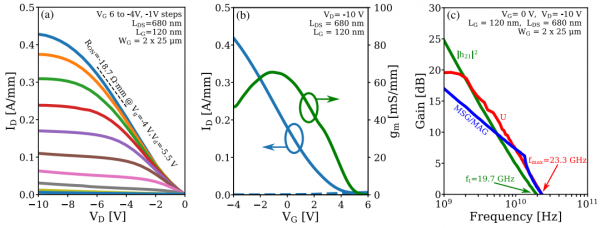
图9:(a)导通电流为-100 mA mm-1的GaN/AlN pFET的输出特性。(b)同一器件的对数,(c)线性传输曲线,突出显示了15 mS mm-1的跨导。曲线图来自Nomoto等人的报导。
随着GaN/AlN pFET导通电流接近与AlN/GaN/AlN HEMT器件相同的数量级,在III族氮化物中匹配n和p电流驱动(以合理的宽度比)终将成为可能。将电流匹配器件与ft、fmax接近毫米波频率的pFET相结合,使AlN平台成为可能,这将开拓宽带隙CMOS的设计空间,并实现此前GaN无法实现的新应用。
BAW滤波器集成
射频通信系统由发射(Tx)和接收(Rx)模块组成。发射模块包括一个高功率放大器(PA),用于产生和发射高频电磁波。这需要由基于适合频率和功率要求的半导体平台的高功率、高频率晶体管来满足。本文前面讨论的使用AlN/GaN氮化物半导体的晶体管为毫米波下的高频和大功率器件提供了解决方案。与发射信号一样重要的是能够接收信号,因为信号在发射过程中被添加了噪声,当天线捕捉到信号时,其强度已大大降低。为了增强信号,接收模块中需要低噪声放大器(LNA)。低噪声放大器是一种有源晶体管,其设计可能与大功率放大器略有不同,以提高该系统的性能。但首先需要从进入接收天线的其他几个频率的噪声中分辨出信号的频率。为此,需要使用无源滤波器。在频率超过100 GHz的毫米波中,将使用SIW,这将在下一节中讨论。本节将介绍10GHz或更低频率的低频滤波器,它们构成了这一频率范围内接收器模块的前端。氮化铝在这一应用中发挥着重要作用,因为氮化铝既有极具吸引力的压电和介电特性,又与CMOS后端线路(BEOL)工艺条件兼容。在这些应用中,AlN是通过在硅平台上溅射沉积来制造滤波器的。越来越多的人正在研究GaN/AlN晶体管外延生长的事实,以便从反面解决这一问题。在此,我们将讨论使这种形式的BAW与氮化物电子器件的外延集成的独特机遇和挑战。
AlN BAW滤波器的工作原理是形成一个金属-绝缘金属声腔,其厚度决定了所需滤波器的中心频率。由于氮化铝的压电特性,电磁波被转换成波长更小的声波,同时保持频率不变,因此空腔谐振器只允许适合的波长通过,而拒绝其他波长。这种行为的品质因子是k2Q 的乘积,其中k2是机电耦合系数,Q是谐振器的品质因数。在1-10GHz窗口内,AlN BAW滤波器的典型值为k2∼0.08和Q∼5000。由于向更高频率发展所需的氮化铝厚度已深入到亚微米级,因此传统溅射技术的结晶质量面临巨大挑战。另一方面,氮化物FET以及紫外LED和激光器中使用的结晶氮化铝已设法在距离生长界面100nm范围内生产出高质量的氮化铝。因此,利用外延氮化铝制造声表面波的可能性非常大。这种方法已得到初步探索,最近甚至通过外延沉积金属电极,实现了使用NbN/AlN/NbN异质结构的全外延EpiBAW 结构。虽然这主要还处于示范阶段,但要发挥其真正的潜力还面临着巨大的挑战。挑战不仅在于对外延AlN层结晶质量和压电性能的控制,还在于避免不希望出现的横向边缘模式,最重要的是控制金属电极的电阻,而金属电极的厚度也必须与AlN层本身的厚度保持一致。
EpiBAW结构带来的更有趣的机会是将其与本文前面介绍的AlN/GaN/AlN HEMT(以及 pFET和氮化物CMOS)直接集成的可能性。利用氮化铝平台提供的直接集成优势,片上氮化物 CMOS可以在氮化物芯片上执行低级数字逻辑运算,然后将重型信号处理交给接收器中的 CMOS后端。但是,对于向100 GHz窗口发展而言,由于金属电极必须缩小到几纳米的厚度,因此此时BAW的电阻损耗似乎难以克服。但幸运的是,AlN集成波导滤波器的能力既可行又有吸引力,这将在下文中讨论。
用于SIW的氮化铝
氮化铝已被广泛用于封装电子设备和电路,包括射频和微波电子设备。在毫米波领域,与石英、玻璃或聚合物相比,AlN的介电常数(k)相对较高,这可以转化为减小微波单片集成电路 (MMIC) 互连尺寸的优势,而微波单片集成电路是高密度相控阵所必需的。例如,SIW主要是在射频和微波电子设备的印刷电路板上开发的。当频率超过100GHz时,无论氮化铝层是生长在原生基底上,还是生长在其他高K基底(如碳化硅、硅或蓝宝石)上,都可以在芯片上实现SIW,用于毫米波MMIC。这是因为,在100GHz以上的高K基材上,SIW的宽度(约为信号波长的二分之一)小于1mm,使得SIW小到足以在芯片上实现。虽然这些高K基材具有相似的介电常数和损耗正切(见表2),但AlN和SiC SIW因其高热导率而对大功率氮化物电子器件特别有吸引力。此外,它们的温度膨胀系数非常接近,可避免在大功率电子器件中产生热应力。它们的机械韧性确保了由数百个基底通孔(TSV)组成的SIW的高产量。值得注意的是,硅、氮化铝和碳化硅的TSV工艺已经发展成熟。

表2. 高介电常数(K)衬底的特性
迄今为止,大多数MMIC采用微带或共面波导作为互连器件,其中的电流被限制在狭窄的金属线路上。相比之下,电流分布在整个SIW横截面上,因而具有更高的功率处理能力。由于被金属TSV和薄膜很好地封闭,SIW的辐射和串扰可以忽略不计,而这对于100GHz以上的互连来说至关重要。事实上,SIW的损耗主要是金属导体损耗,而不是辐射损耗或介质损耗。这也是高电阻率硅和碳化硅虽然不是真正的绝缘体,但在140GHz左右总损耗小于0.5dB mm-1的SIW被证实的原因。研究还表明,SiC SIW的损耗比相同材料制成的微带或共面波导低三倍。最后,随着频率的增加,SIW的损耗会降低,而微带或共面波导的损耗会增加。
除了低损耗和大功率互连外,SIW还可用作高质量阻抗变压器、滤波器和天线,这些都是大功率电子器件中的关键元件,但以往很难集成到芯片上。通过在SIW中添加调谐TSV,可以轻松实现阻抗变压器的制备。通过将调谐TSV与压电控制的氮化铝变容器耦合,可实现类似于石英SIW在Ka波段实现的可调滤波器。SIW天线是天然的边缘发射器,考虑到散热要求,它比表面发射器更适合大功率相控阵。
结论
GaN HEMT在毫米波频率的功率和效率方面的快速进步使其在未来各种无线通信系统中将发挥重要作用。本文概述了AlN如何通过改进HEMT设计和开发氮化物集成的新可能性来进一步发挥其作用。将优化的GaN放大器性能、接近电流匹配的氮化物CMOS以及最先进的BAW 滤波器和SIW整合在同一热传导AlN平台上,将在一个完全集成的大功率芯片上实现数字逻辑和模拟系统的整合。这种引入AlN的系统有希望打开GaN电子器件此前未曾触及的新应用领域,并一窥III族氮化物材料系统的真正潜力。
原文源于【IOPSCIENCE】
(以上文章由奥趋光电翻译,如有涉及版权等问题,请联系我们以便处理)


























