译自原文
Robust Al0.23Ga0.77N channel HFETs on bulk AlN for high voltage power electronics
原文作者
J.Mehtaa, I.Abida, R.Elwaradib, Y.Cordierb, F.Medjdouba
原文链接
https://doi.org/10.1016/j.prime.2023.100263
项目支持方
法国RENATECH Network,GaNeX“投资未来”计划,ACTION计划
摘要
AlxGa1-xN异质结场效应晶体管(HFET)一直是高压电力电子器件领域的研究焦点,凭借其可以通过改变铝组分实现可调节的高临界击穿场强,从而具备了超越前代产品的潜力。在这项工作中,我们展示了在体AlN单晶上的Al0.23Ga0.77N沟道HFET,其具有大于300 mA/mm的最大漏极电流密度,以及特有的Ron= 4 mΩ·cm2,测量到的缓冲击穿电场大于10 MV/cm。此外,还对接近各自硬击穿电压的Al0.23Ga0.77N沟道HFET和薄GaN HFET进行了高压可靠性比较,结果表明Al0.23Ga0.77N沟道HFET在高达80%的硬击穿电压下仍能可靠运行,并且在2000 V电压扫描后仍能保持稳定的ION/IOFF比。
关键词
高频晶体管(HFET),氮化铝镓(AlGaN),超宽禁带(UWBG),高压电力电子器件(High Voltage Power Electronics),氮化铝(AlN),场效应晶体管(HEMT)
引言
几十年来,绝缘栅双极晶体管(IGBT)和金属氧化物半导体场效应晶体管(MOSFET)一直引领着高压电力电子产品的发展,可提供能承受数千伏电压的最佳性能。2013年,Wolfspeed 公司(前身为CREE公司)展示了额定功率最高的SiC IGBT,其有源面积为 42 平方毫米,击穿电压为20.7千伏,使用的漂移层为160微米,峰值电场为1.58 MV/cm。这种结构厚度最终增加了高压转换器模块中器件的占地面积和体积。如今,GaN高电子迁移率晶体管(HEMT)和碳化硅MOSFET引领着高压和射频(RF)功率电子器件的工业发展,其最高额定功率可达1700 V和325 A,结温高达423 K。然而,对于横向器件结构而言,这些材料的临界电场强度已达到< 3.4 MV/cm的峰值,从而限制了它们在多千伏范围内的工作。近十年来,AlGaN、AlN等可提供高达15 MV/cm击穿电场的超宽禁带(UWBG)半导体在高压场效应晶体管的开发中表现突出,它们在减小整体器件尺寸的同时,还为实现更薄的异质结构铺平了道路。然而,AlGaN沟道中铝组分的增加最终会使触点在应用传统的Ti/Al/Ni/Au金属叠层后进行< 800℃的快速热退火(RTA)时发生整流。2008年,T.Nanjo等人首次展示了Al0.53Ga0.47N/Al0.38Ga0.62N HEMT,栅漏间距(LGD)=10 μm时的击穿电压为1650 V。2019年,美国桑迪亚国家实验室证明了Al0.85Ga0.15N/Al0.7Ga0.3N HEMT的极端温度工作性能,在500℃时,直流输出降低了58%,漏电流较低,开关电流损失极小。2021年,I.Abid等人证实AlN/Al0.5Ga0.5N晶体管可承受高达4300 V的电压,漏电流密度低于1 μA/mm,LGD=40 μm。
许多不同类型的衬底(如蓝宝石、硅、氮化铝等)已被用来生长高质量的氮化铝沟道异质结构,并证明了它们在下一代功率器件中的极端电压和温度性能。与GaN HEMT相比,AlGaN/AlGaN异质结构的主要缺点是由于高合金无序散射导致二维电子气(2-DEG)中的电子迁移率较低,从而导致了器件的低输出电流。2022年,J.Singhal等人详细研究了铝组分高达0.74的AlN/AlGaN/AlN双异质结构中极化诱导的2-DEG的电荷控制和传输特性,并根据与温度相关的传输特性概述了合金散射。2-DEG的质量还取决于外延衬底的选择。因此,采用体块AlN单晶衬底可以改善AlGaN/AlGaN异质结构的2-DEG性能和整体晶体质量。在本研究中,我们将亚微米GaN沟道HEMT与在体AlN上制备的Al0.23Ga0.77N沟道HEMT进行了比较,分析了它们的传输和输出特性以及高压工作情况。
FET的高电压可靠性和稳定性是将器件推向实际应用的关键前提条件。多年来,人们利用随时间变化的阶跃应力测量技术,对射频和功率器件用GaN HEMT进行了大量研究,以了解陷波、去陷波和材料降解机制。例如,650V的横向GaN功率开关已获得多家工业公司的认可,但由于不存在雪崩击穿,设计明显过高,这仍然困扰着大批量的市场渗透。因此,扩大接近击穿电压的安全工作区域可在给定电压范围内缩小器件尺寸。在这项工作中,我们通过实验证明了这些器件在接近硬击穿电压时的可靠性和稳健性,并最终评估了安全工作电压。
结构特性与器件制备
异质结构是在Riber Compact 21反应器中通过氨源分子束外延(NH3-MBE)生长在HexaTech公司生产的直径为2英寸的商用块状氮化铝衬底(AlN-10系列)上的。首先,在850-900℃温度范围内分别为AlGaN沟道异质结构和GaN沟道异质结构重新生长90nm和250nm厚的AlN缓冲层。然后,将两种异质结构的生长温度降至790-800℃以生长剩余的外延层,如图1a所示。原子力显微镜(AFM)证实两种异质结构的表面都很光滑,在2×2μm2和10×10μm2区域扫描的均方根粗糙度(RMS)都低于1nm。图1b所示的高分辨率X射线衍射(HRXRD)分析表明,GaN沟道层的应变松弛率限制在71%,与该层相对应的(302)Ω扫描峰的半最大全宽(FWHM)为0.7°。这些结果表明,GaN的厚度不足以有效过滤在与AlN缓冲层的界面上成核的大多数穿线位错,正如在一系列生长了GaN沟道厚度从8纳米到500纳米的类似结构中观察到的那样。另一方面,Al0.23Ga0.77N沟道HRXRD分析表明,该层几乎完全是应变松弛的(松弛率为86%)。该层对应的(302)Ω扫描峰的FWHM为0.64°。因此,Al0.23Ga0.77N沟道的晶体质量略好于GaN沟道异质结构,穿线位错较少,这是因为AlN的晶格失配应变较小,加上厚度较大。此外,由于位错的主要部分是在沟道/AlN接口附近成核和弯曲的,因此这两种结构的一个主要区别是,较厚的沟道可以增加沟道顶部诱发的二维位错与底部缺陷接口之间的距离。
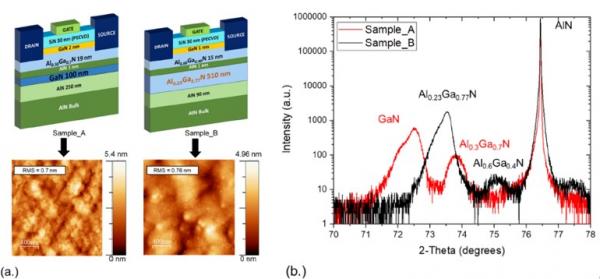
图1:(a)Al0.3Ga0.7N/GaN和Al0.60Ga0.40N/Al0.23Ga0.77N沟道异质结构的横截面示意图及其各自的原子力显微镜扫描图;(b)GaN和AlGaN的HRXRD ω/2Ɵ扫描图。
器件制作首先使用BCl3/SF6化学物质对两种情况下的AlGaN势垒进行部分蚀刻,然后使用电感耦合等离子体(ICP)蚀刻,最后使用缓冲氧化物蚀刻溶液进行表面湿处理。Ti/Al/Ni/Au触点的电子束蒸发是在Plassys MEB550SL中进行的,然后分别用825℃和850℃的RTA对GaN和AlGaN沟道HFET进行蒸发。这些器件通过ICP一直到AlN衬底进行了介子隔离。在电子束蒸发镍/金栅极触点之前,通过等离子体增强化学气相沉积(PECVD)沉积了30 nm的SiN介电层,以钝化器件表面。掩膜中的LGD变化范围为5-40 μm,而栅极长度(LG)为3 μm,栅极-源极间距(LGS)为2.5 μm。最后,蒸发制备Ti/Au电极,完成金属绝缘体半导体(MIS)-HFET的制备过程。
器件表征与结果
霍尔测量是在使用Van der Pauw图形化晶圆上进行的。GaN沟道器件的2-DEG迁移率预计会随着沟道缩小而降低,这是由于散射效应增加以及可能涉及到再生长界面,而再生长界面比AlGaN沟道HFET更接近2DEG。GaN沟道HFET在100 nm厚的沟道中显示出约840 cm2/(V.s),而厚GaN沟道通常高于1500 cm2/V.s。如表1所示,AlGaN沟道HEMT的电子迁移率约为340 cm2/(V.s),2DEG电子密度在1013 cm-2范围内。高压电测量使用Keysight B1505A功率器件分析仪/曲线跟踪仪和Keysight N1268A超高压扩展器进行,样品浸泡在氟惰性FC-40中,以避免在空气中产生电弧。图2a显示了漏极-源极电压(VDS)=10 V时样品的传输特性及其各自的栅极漏电流特性。从正向和反向传输特性之间的低滞后可以看出,所测量的器件在栅极下方的陷波较低。如图2b所示,GaN和Al0.23Ga0.77N沟道HFET的输出特性显示,最大漏极电流密度(IDS)分别约为180 mA/mm和320 mA/mm。对于LGD=5 μm的晶体管,尽管欧姆接触电阻仍可优化,但在VGS=0 V的线性条件下,计算得出的比容约为4 mΩ·cm2。在过去十年中,许多研究小组都在努力开发不同的技术,如分级接触、掺杂势垒接触和各种金属堆叠方案,以获得低至1.9×10-6 Ω·cm2的欧姆接触电阻。

表1:室温下的霍尔效应测试
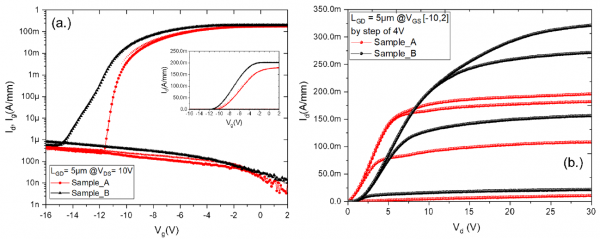
图2:(a)Al0.3Ga0.7N/GaN和Al0.60Ga0.40N/Al0.23Ga0.77N沟道MIS-HFET的正向和反向扫描传输特性,以及(b)VGS=[-10,-6,-2,2]V时VDS=30 V的输出特性。
图3a显示了接触间距为1μm、接触面积为100 μm×100 μm的AlN横向击穿特性,在漏电流密度小于10 μA/mm的情况下,击穿电压平均值大于1000 V。从图3a的插图中可以看到,在接触间距较小的情况下,两种结构的缓冲击穿场均高达10 MV/cm,这揭示了UWBG材料的潜力。图3b显示了不同接触间距的AlN两端击穿特性,接触间距为63 μm时击穿电压达到7 kV,插图显示了GaN和Al0.23Ga0.77N沟道HEFT在AlN衬底内的介子高度分别为380 nm和620 nm。
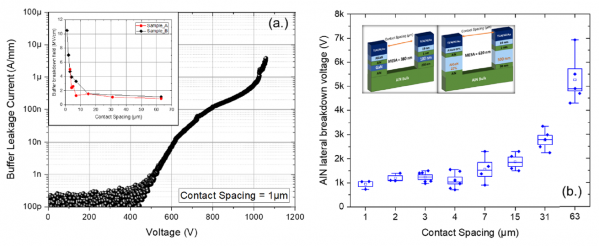
图3:(a)触点间距为1μm时的缓冲漏电流特性,以及(b)Al0.3Ga0.7N/GaN和Al0.60Ga0.40N/Al0.23Ga0.77N沟道MIS-HFET不同触点间距的AlN横向击穿电压平均值。
三端击穿特性(见图4a)表明,两种样品的硬击穿都是由栅极泄漏电流引发的。对于大LGD,Al0.23Ga0.77N沟道HFET的击穿电压(VBK=2500 V)比薄GaN沟道HFET高4倍。图4b显示了在栅极漏电流密度为100 μA/mm时,晶体管阻塞电压随不同栅漏间距的变化情况。不出所料,这表明Al0.23Ga0.77N沟道HFET每微米的阻塞电压是GaN沟道HFET的5倍。
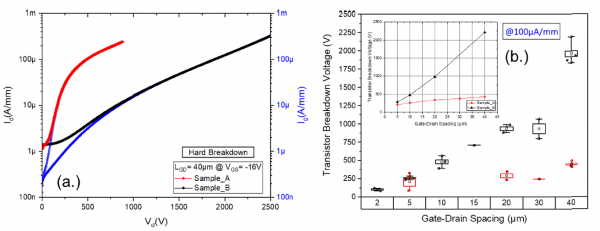
图4:(a)VGS=-16V时栅漏间距为40μm的晶体管硬击穿特性,(b)不同栅漏间距的Al0.3Ga0.7N/GaN和Al0.60Ga0.40N/Al0.23Ga0.77N沟道MIS-HFET晶体管阻塞电压的平均值。
高电压下的可靠性测试
我们开展了一种离态应力实验,该实验基于将LGD=40 μm的晶体管的VDS压升至接近GaN和Al0.23Ga0.77N沟道HFET的硬击穿电压。如图5(a)所示,器件分步升至多个电压。在每个VDS下重复测试30次,以稳定器件的离态漏电路径,以检测到任何器件劣化。每个VDS压升在20秒内完成。每次压升后,在10秒内测量器件的传输特性。可以发现,GaN沟道HFET的关态漏电流密度在VDS压升=200 V之前相当稳定,而从VDS压升=300 V 开始,栅极漏电流增加了两倍。这就形成了一条不可逆的栅极漏电流路径(见图5b),几周后检查确认了永久降解,这可能是由反压电效应造成的。如图5c所示,Al0.23Ga0.77N沟道HFET表现出卓越的性能,器件可稳定工作到2000 V(接近硬击穿电压)。Al0.23Ga0.77N沟道HFET在高电压下的卓越稳定性反映了采用更宽带隙的优势。

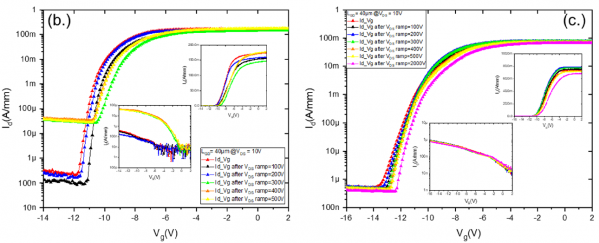
图5:(a)不同VDS压升下的稳定性测试示意图,(b)Al0.3Ga0.7N/GaN沟道MIS-HFET在每个VDS斜坡后测量的传输特性,以及(c)Al0.60Ga0.40N/Al0.23Ga0.77N沟道MIS-HFET在每次VDS压升后测量的传输特性,其插图显示了栅极漏电流密度。
考虑到稳定性测试,根据硬击穿电压定义安全工作离态阻断电压,可以得出晶体管压降。测量的GaN和Al0.23Ga0.77N沟道HFET的硬击穿电压分别为780 V和2500 V。如图6a所示,GaN和Al0.23Ga0.77N沟道HFET的安全工作关断电压定义为器件在关断状态漏电流出现衰减(如绿线所示)后的电压。可以看出,薄GaN沟道晶体管需要65%的压降才能实现安全的离态工作。另一方面,Al0.23Ga0.77N沟道晶体管尽管不够成熟,但其硬击穿压降仅为20%,甚至低于最先进的商GaN HEMT和FET的30%压降。图6b显示了稳定性测试期间栅极漏电流的最大变化,考虑到新器件,多个VDS提升电压归一化为100%。Al0.23Ga0.77N沟道HFET在高达2000 V的电压下,栅极漏电流的最大变化小于200 nA/mm,这表明栅极漏电流非常稳定,从而实现了高度稳定的ION/IOFF比(见图6b插图)。另一方面,GaN沟道HFET在每次VDS扫频后,由于产生永久漏泄通路,新器件的漏泄波动很大。
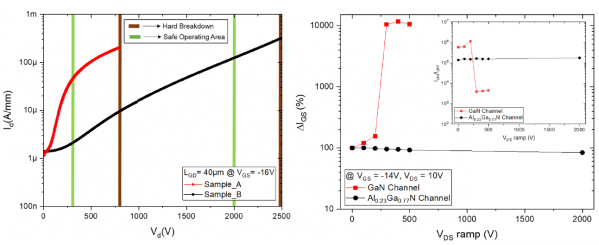
图6:(a)漏极漏电流对应用VDS的晶体管电压降额,(b)GaN和Al0.23Ga0.77N沟道HFET在不同VDS压升迭代时的栅极漏电流密度最大变化(插图:ION/IOFF比)。
结论
AlGaN沟道和GaN沟道HFET异质结构是在体块AlN单晶衬底上生长的。HRXRD和AFM扫描显示,与GaN沟道HFET相比,Al0.23Ga0.77N沟道HFET的晶体质量更好,表面粗糙度更低,这是因为Al0.23Ga0.77N与AlN衬底的晶格失配更低。Al0.23Ga0.77N沟道器件的ID值高达320 mA/mm,线性比容低至4 mΩ·cm2,尽管漏极/源极欧姆接触仍可优化。横向击穿测试显示,AlN单晶的质量很高,在接触间距较小的情况下,临界击穿场强达到10 MV/cm。两种器件的晶体管击穿电压都随栅-漏间距的变化而变化。Al0.23Ga0.77N沟道器件的硬击穿值高达2500 V,而GaN沟道HFET器件的硬击穿值为780 V。所制备的Al0.23Ga0.77N和GaN沟道HFET的Baliga功率值分别约为120 MW/cm2和3 2MW/cm2。有趣的是,Al0.23Ga0.77N沟道HFET在高达2000 V的电压下仍能保持稳定的性能,而GaN沟道HFET在压升至300 V后会出现永久性衰减。稳定性测试还证实了Al0.23Ga0.77N沟道HFET的可靠性,其压降仅为20%,而GaN沟道HFET则超过50%。这项工作证实了采用AlGaN沟道的优势,即在高电压稳健性方面,可以实现比GaN HEMT更接近硬击穿的安全工作离态电压。
原文源于【ScienceDirect】
(以上文章由奥趋光电翻译,如有涉及版权等问题,请联系我们以便处理)


























