原文标题
Extreme-temperature devices using AlN
---Diodes and transistors with AlN channels deliver high breakdown voltages and operation at incredibly high temperatures.
---具有AlN通道层的二极管和晶体管具有高击穿电压,并能在极高的温度下工作。
原文刊登于英文杂志Compound Semiconductor Magazine,
原文作者
日本筑波大学Hironori Okamura
英文链接
https://data.angel.digital/pdf/Compound_Semiconductor_Issue_1_2024.pdf#page=50

高温探针台(ExPP 有限公司出品)。借助钨探针、陶瓷加热器、蓝宝石视窗和薄型样品台,最高测量温度可达1173K。R型热电偶可监测陶瓷加热器下的温度。
为探索资源,人类的许多活动都在向极端环境扩展。这使得探索活动朝着不同的方向发展,包括深入地下、潜入深海以及探索深空。在所有这些环境中,温度都是极端的--金星表面、深井钻探和运转中的发动机内部空间的温度都超过了 300 °C。为了更深入地了解所有这些环境,需要部署传感器。然而,最显而易见的传感器——即基于Si的传感器——无法胜任这一任务,因为它们的工作温度相对较低。这意味着,为了丰富我们的生活环境,需要开发极端温度电子器件。
所有类型的半导体器件在极端温度下工作时,它们都会面临与材料、电极、栅氧化层和封装相关的问题(见图1)。随着温度的升高,由于电子从价带最大值激发到导带最小值,会产生大量的电子-空穴对。这些电子会增加本征载流子浓度(见图2(a)),这对器件是有害的,因为它们会增加器件的漏电流,阻止器件关闭。减少漏电流的方法包括引入具有带隙能量更大和本征载流子浓度更低的半导体材料(见图2(b)),或者限制来自通道层以外区域的电流扩散。采用被高电阻率层包围的通道层可以提高器件的工作温度,这些高电阻率层具有有效施主/受主浓度低和低缺陷浓度的特点。另一种方法是使用具有p-n结的器件,如JFET和BJT。在这些情况下,选择与基础半导体反应性最小的难熔金属作为电极也很重要。在这方面,钛、钒、钽、钼、钨和铂优于铝、镁、铜、银、铟和金等电极材料。
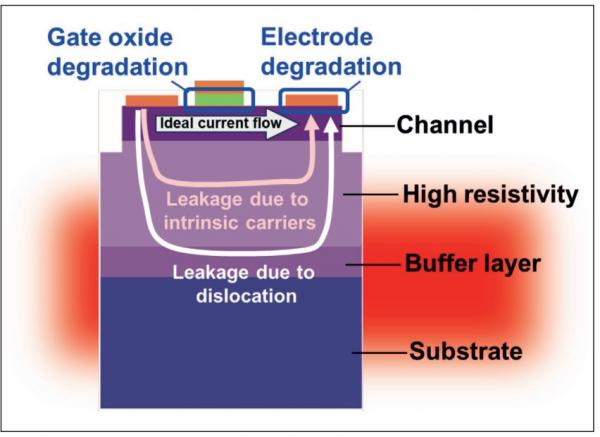
图1所示为具有栅氧化层的MESFET(金属-半导体场效应晶体管)中的漏电流路径和热退化点。
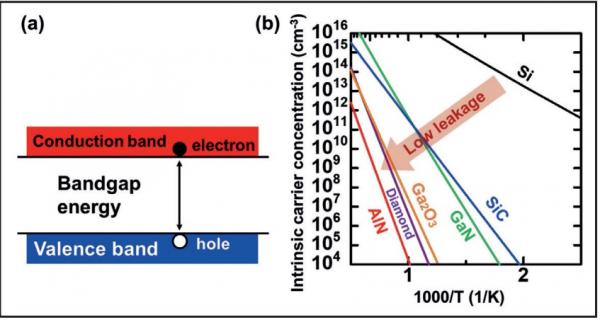
图2(a)显示了高温下产生电子-空穴对的情况。(b)显示了硅、SiC、GaN、β-Ga2O3、金刚石和AlN的本征载流子浓度随温度倒数变化的函数。
为什么使用AlN?
有许多半导体材料的带隙能量大于硅。这些材料包括SiC (3.3 eV)、GaN (3.4 eV)、Ga2O3 ( 4.7-5.2 eV)、金刚石(5.5 eV)和AlN (6.1 eV)。美国国家航空航天局(NASA)的Philip Neudeck领导的研究团队报告称,SiC JFETs可以在超过800℃的温度下工作。虽然这无疑是一个令人印象深刻的结果,但具有更宽带隙的材料有望达到更高的温度。然而,其中不少材料存在重大缺陷。例如,GaN的有效施主浓度高达1016 cm-3;无法形成p型Ga2O3层;金刚石在大约700℃时开始与氧气发生反应。与此形成鲜明对比的是,AlN没有明显的缺陷,提供了热稳定性和可控的掺杂。鉴于这些属性,我们筑波大学的研究团队一直致力于AlN的研究,以开发耐极端温度的器件。
历史上,人们一直认为AlN仅是优良的绝缘体。然而,大约20年前,日本电信电话株式会社(NTT)的Yoshitaka Taniyasu及其同事通过金属有机化学气相沉积(MOCVD)技术生长出了导电的AlN层,证明了AlN并非仅限于作为绝缘体。该团队记录下了掺硅AlN层的电子迁移率为426 cm²V⁻¹s⁻¹,掺杂浓度为3×10¹⁷ cm⁻³。在这项工作的基础上,他们继续开拓p型AlN的生长技术,并展示了首个波长为210 nm的AlN发光二极管(LEDs)以及准垂直的AlN p-n二极管。正是这些成功推动了基于AlGaN和AlN的深紫外LEDs的近期快速发展。
除了光学器件外,研究界还研究了AlN肖特基势垒二极管和AlN/AlGaN高电子迁移率晶体管(HEMTs),以探索其高临界电场的潜在优势。不幸的是,这些器件由于施主和受主的高电离能(Si为0.3 eV,Mg为0.6 eV)而遭受低载流子浓度的困扰。因此,这两种掺杂剂的有效载流子浓度比它们的掺杂浓度低约两个数量级,导致器件具有非常小的电流。为了解决这个问题,我们筑波大学的研究团队与麻省理工学院(MIT)和阿尔托大学(Aalto University)的研究人员合作,通过在N极性AlGaN/AlN结构中引入极化诱导掺杂,开辟了新天地。得益于自发极化和压电极化,这种掺杂形式可以增加电流并降低接触电阻率。利用极化诱导掺杂,我们成功展示了首个N极性AlN基PolFETs和HEMTs,其漏电流超过100 mA·mm⁻¹。这样的成功使我们认识到AlN作为电子器件实用半导体材料的巨大潜力。
为了制备这些器件,我们已经能够利用多家材料供应商的资源。可以从Dowa Electronics Materials购买高质量的2 inch蓝宝石衬底上的AlN样品,同时也可以从Stanley (即Hexatech,译者注)和Asahi Kasei(即Crystal-IS)这两家公司商购获得2 inch的单晶AlN衬底。
AlN掺杂
控制半导体中掺杂剂浓度的关键在于在晶体生长过程中引入杂质,以及通过热扩散和可能的离子注入来实现。离子注入技术具有吸引力,因为它可以实现精确的剂量控制并确保掺杂剂的高横向均匀性。然而,当采用高剂量注入时,往往会对晶格造成损伤,并引入高浓度的点缺陷,这些点缺陷可能会补偿载流子。幸运的是,大部分这种损伤可以通过后续的热退火处理来修复,我们在制备硅注入的n型AlN沟道时就采用了这种方法。
AlN晶体的一个令人印象深刻的特点是其高温下的稳定性,包括在高达1700℃的氮气氛围下的稳定性。这种稳定性为修复注入损伤提供了广阔的温度空间——这一过程需要对硅注入的AlN层进行电激活,所需温度高于1200℃。
需要注意的是,在选择退火温度时需要深思熟虑,因为这可能会导致材料中的其他变化。超过1400℃时,硅和氧杂质会在层内扩散。由于蓝宝石衬底在氮气氛围下于1500℃分解,氧原子会从蓝宝石衬底扩散出来,因此在高温退火后,蓝宝石衬底上的薄AlN层将具有较高的氧浓度,从而导致电学性能下降。

图3(a) 展示了在1600°C退火后,3 μm厚的硅注入AlN层中硅、氧和碳的杂质浓度深度分布。图3(b)显示了退火后1 μm厚的镁注入AlN层中镁浓度的深度分布。
通过与麻省理工学院(MIT)、阿尔托大学(Aalto University)、东京电子器件公司(TNSC)和同和电子材料公司(Dowa Electronics Materials)的合作,我们研究了硅、氧和镁原子在AlN中的扩散(见图3)。我们的研究发现,使用3 μm厚的AlN层退火后,从蓝宝石衬底扩散的氧原子无法到达通道层。这使我们得出结论,对于含有硅和镁注入物的导电AlN层,首选的退火温度范围分别是1200-1600°C和1400-1500°C。这一知识使我们能够展示首批AlN通道层晶体管。当器件的制造过程涉及接近平衡态的条件时,如外延生长和高温退火,会倾向于形成具有250-320 meV电离能的深能级状态。这往往会导致硅施主的自补偿现象,这与我们的研究结果是一致的。
与此同时,非平衡过程的使用,如离子注入,可以增加具有64-86 meV电离能的浅施主的数量。这使得北卡罗来纳大学的Hayden Breckenridge及其同事以及Adroit Materials公司能够通过硅注入和在相对较低的温度下(1200 °C)退火,制造出高度导电的AlN层。另一个令人鼓舞的结果来自京都大学,即AlN中替代镁受主的结合能仅为250-410 meV,这个值远小于常见MOCVD生长的AlN层中镁受主的电离能。综合这些结果表明,如果在掺杂硅和镁的AlN中可以可重复且容易地控制非平衡过程条件,这可能会为电子和光学器件的性能显著提高打开大门。
AlN的电学特性
为了提高基于AlN的器件的电学性能,除了解决由于低载流子浓度而导致的n型和p型AlN层的高电阻率问题外,还需要解决由于电子亲和力小而导致的高接触电阻率问题。在AlN中实现室温下的欧姆接触尤其具有挑战性。电压降低受肖特基势垒高度的控制,该高度取决于金属功函数和半导体电子亲和力之间的差异。通过适当选择电极材料可以降低势垒高度,从而形成欧姆接触。n型AlN的可选材料包括钛、铝、钒和钼,而p型AlN的欧姆接触可以使用钯和NiO。
半导体材料中重掺杂的一个影响是减少了耗尽区的宽度,从而导致通过势垒的隧穿现象。对最顶层AlN表面进行重掺杂对于欧姆接触非常重要。然而,由于AlN层中硅和镁掺杂剂的浓度限制在大约1019 cm-3,可能是由于补偿缺陷的形成,因此场致发射隧穿没有前景。
为了确定半导体结构中的载流子浓度和载流子迁移率,研究人员倾向于进行霍尔效应测量。由于这些测量需要欧姆行为,一些研究使用了重掺杂的GaN接触层,这样就能确定AlN在室温和高温下的电特性。我们与其他人一起评估了超过200 °C和500 °C的n型和p型AlN高温下载流子浓度和载流子迁移率。在进行这项研究时,我们发现了一个与高温测量相关的新问题。由于缺乏极端温度的键合和封装技术,我们不得不使用探针台。我们还发现普通探针头在高温下会退化。请注意,大多数报告的器件最高工作温度不超过500 °C,这意味着在高于此温度的电学性质测量是不可靠的。
我们与Dowa Electronics Materials合作,使用可提供最高测量温度为900 °C的高真空高温探针系统,评估了在蓝宝石衬底上的3 μm厚AlN层的电学特性。为此,我们在室温下将硅注入AlN层以获得n型导电性:在150 nm深的盒状剖面中浓度为2×1019 cm-3。这些硅注入的AlN层随后在1500 °C下退火。然后我们在950 °C下烧结之前,沉积了Ti/Al/Ti/Au电极以形成欧姆接触。
我们的电极在877°C时退化,可能是由于Ti/Al与AlN之间的反应所致。这促使我们寻找适合在极端温度下形成欧姆接触的金属。在我们能够考虑的温度范围内,我们观察到在127°C以下电流-电压关系是非线性的,而在227°C以上几乎是线性的。评估227°C至827°C之间的电学性质发现,随着温度的升高,薄层电阻和接触电阻率降低。从227°C到627°C,随着温度的升高,电子迁移率略有下降,但由于施主电离增强,电子浓度增加,导致高温下薄层电阻降低。这使我们得出结论,n型AlN层在极端温度下表现出优异的性能。
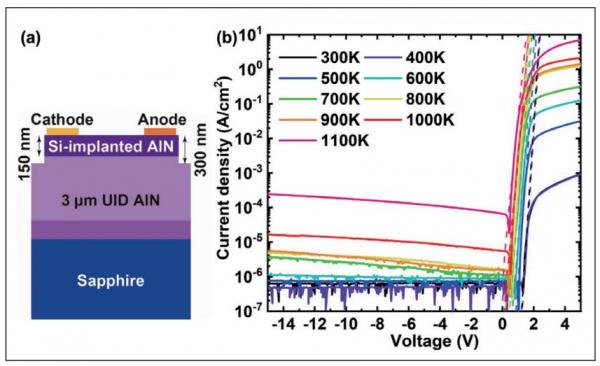
图4:(a)具有硅注入AlN沟道的肖特基势垒二极管的横截面。Ni/Au阳极和Ti/Al/Ti/Au阴极。(b)AlN肖特基势垒二极管从27 °C到827 °C的电流密度-电压特性。
二极管和晶体管
我们在蓝宝石衬底上制备了硅注入AlN层的肖特基势垒二极管和MESFET。我们的二极管能够在827 °C下工作(见图4),超过了所有先前的记录,而我们的晶体管可以在高达727 °C的温度下工作(见图5)。AlN肖特基势垒二极管在室温下的击穿电压为610 V,而AlN MESFET在727 °C时的相应值为176 V。我们想强调的是,这些器件实际上是可行的,因为它们的结构简单,而且AlN层是在大型、低成本的蓝宝石衬底上生长的。
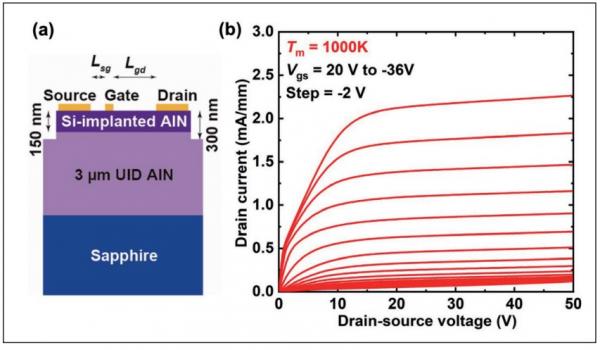
图5:(a)硅注入AlN沟道的MESFET横截面示意图。(b)727 °C时AlN MESFET的直流输出特性。
为了制造我们的肖特基势垒二极管和MESFET,我们使用Ni/Au作为阳极和栅极接触。我们发现镍在热稳定性方面表现出色,即使在827 °C下也几乎不与AlN发生反应。更重要的是,在电学特性方面,我们发现Ni/Au和Pt/Au之间几乎没有差异。对于肖特基势垒二极管,由于固有载流子浓度低且Ni/AlN界面热稳定,因此即使在827 °C下,截止电流也很小。然而,由于底部未掺杂AlN层的泄漏和高缺陷浓度,AlN MESFET在727 °C时的截止状态漏电流很高。器件的电流在高温下会因声子散射而下降,与此不同,我们发现氮化铝肖特基势垒二极管和 MESFET 的正向电流会随着温度的升高而持续增加,直至 827 ℃。我们将这归因于在极端温度下AlN器件中的电流主要由电子浓度的增加和接触电阻率的降低所主导,而电子迁移率的降低起次要作用。
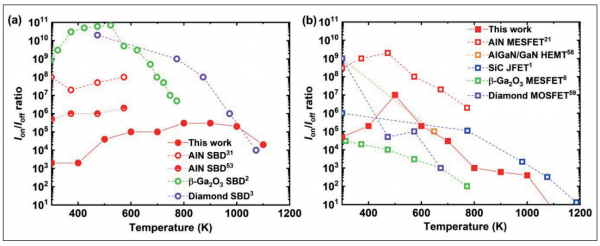
图6:基准测试图,比较了AlN器件的电流开/关比率与其他最先进的(a)肖特基势垒二极管(SBDs)和(b)场效应晶体管(FETs)的测量温度。
我们开发AlN器件为制造能在极端温度下工作的半导体器件开辟了一条新路。尽管肖特基势垒二极管(SBDs)和FETs的开/关比率与温度之间存在权衡(见图6),但AlN器件仍有很大的改进潜力。例如,通过同质外延生长和引入JFET结构的结合,应该可以提高极端温度下的开/关比率。额外的改进可能来自于引入耐热欧姆接触,而不是Ti/Al/Ti/Au,这样做可以将工作温度提高到877 °C以上。
对于大多数极端温度应用,集成电路需要在长时间内可靠地运行。这样的电路是用互补技术制造的,具有n型和p型通道。在京都大学,工程师们开发了一种能在350 °C下运行的SiC互补JFET逻辑门。我们希望朝着类似的方向推进我们的工作,制造出能够在极端环境中运行的同质外延AlN通道的互补JFET。
原文刊登于英文杂志Compound Semiconductor Magazine
(以上文章由奥趋光电翻译,如有涉及版权等问题,请联系我们以便处理)


























